AI/HPC处理器的功耗演进与先进封装的散热核心挑战
2025 年 12 月,国际电子器件会议(IEDM)短期技术解说课程上,全球硅制造龙头台积电(TSMC)发布了最新封装技术动态。本次演讲主题为《面向人工智能与高性能计算(AI/HPC)的先进封装及芯片技术》,演讲者为台积电 NCED(先进封装工程部门)软件集成事业部研发总监 Adva James Chen,其分享聚焦 AI/HPC 处理器的功耗演进与先进封装的散热核心挑战。
AI/HPC 处理器 TDP 的爆发式增长
回顾近十年 AI/HPC 处理器的最大功耗(TDP)演变,其增长速度远超行业预期:2016 年,NVIDIA GP100 处理器的 TDP 约 250 瓦;2018 年,AMD MI50 将这一数值提升至 300 瓦;2021 年 AMD MI250 的 TDP 跃升至 560 瓦,2023 年 AMD MI300 进一步突破至 700 瓦;2024 年,NVIDIA GB200 在强制空冷条件下 TDP 达到 1000 瓦;而到 2025 年,AMD MI355X 在液冷方案支持下,TDP 已急剧增长至 1400 瓦。值得注意的是,作为 AMD MI355X 的强制空冷版本,MI350X 的 TDP 为 1000 瓦,这也印证了当前技术体系下,空冷方案的功耗极限约为 1000 瓦。

AI/HPC 处理器最大功耗(TDP)演进(2016-2025)。来源:台积电(TSMC)IEDM 2025
热阻对封装温升的核心影响
对于 CoWoS(晶圆级系统集成)等先进封装技术而言,其核心结构是将系统级芯片(SoC,含 GPU 或 AI 处理器)与高带宽内存(HBM)集成于中介层(中间基板)之上,如何高效散逸这两大核心元件产生的热量,成为决定封装性能与可靠性的关键。
定量描述热传递阻力的核心指标是 “热阻(单位:°C/W)”,其物理意义为单位功耗(W)所引发的元件温升(°C),热阻值越低,散热效率越高。在实际工程设计中,单位面积热阻(单位:mm²・°C/W)同样被广泛应用,用于精准评估不同区域的散热能力。
CoWoS 封装的散热设计需综合考量全链路热阻:包括作为热源的硅芯片本身热阻、连接硅芯片表面与金属散热盖的导热界面材料(TIM1)热阻、金属散热盖自身热阻、连接散热盖与外部散热器的导热界面材料(TIM2)热阻,以及散热器的热阻。散热设计的核心原则是将硅芯片的 PN 结温度控制在阈值以下(行业通用标准约 70°C):假设环境温度为 25°C,可允许的最大温升(温差)为 45°C;而在数据中心等专业场景中,通过环境控温将室温降至 20°C 以下的情况十分普遍,此时可允许的温升范围可扩展至 50°C 以上,为散热设计提供更多余量。
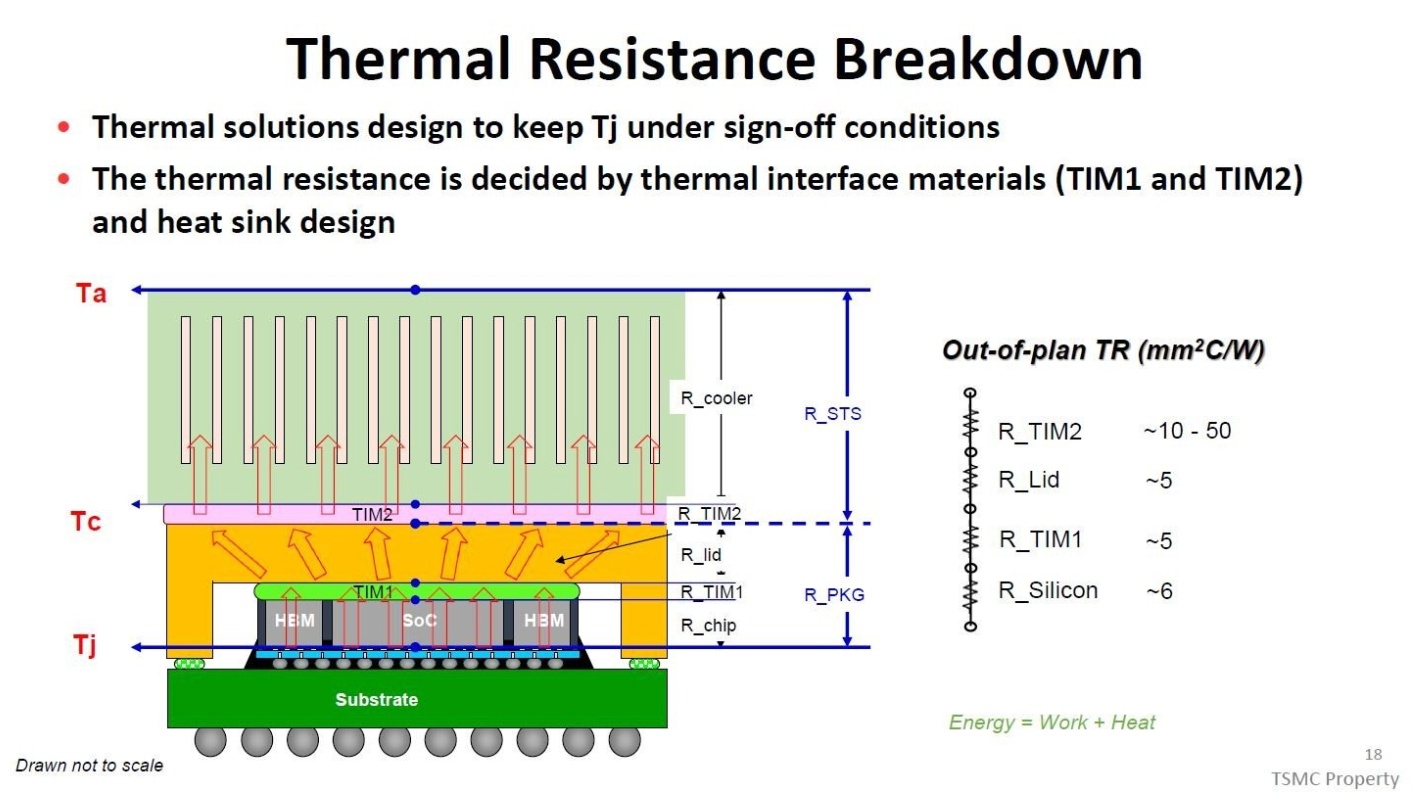
先进封装(CoWoS)的冷却机制与元件热阻构成。来源:台积电(TSMC)IEDM 2025
随着 AI/HPC 处理器 TDP 向 1400 瓦级突破,传统散热方案已逐渐逼近物理极限。一方面,空冷方案在 1000 瓦以上功耗场景中,难以通过单纯增大散热器体积或提升风扇转速实现有效散热,还会引发噪音超标、能耗效率下降等问题;另一方面,现有导热界面材料(如传统硅脂、相变材料)的热阻已无法满足高功率密度下的散热需求,TIM1 与 TIM2 的热阻损耗在全链路热阻中占比逐渐升高,成为制约散热效率的关键瓶颈。
针对这一挑战,台积电在 CoWoS 封装技术中推出了多项创新优化:
- 新型低阻导热界面材料(TIM)应用:研发高导热率纳米复合材料 TIM1,将热阻显著降低,同时优化材料的界面浸润性,减少芯片与散热盖之间的接触间隙,降低接触热阻;
- 集成式金属散热盖优化:采用高导热系数的铜合金或金刚石增强铜材料制作散热盖,并通过精密锻造工艺提升散热盖的表面平整度,同时在盖体内部设计微通道结构,增强热量在盖体内部的横向传导效率;
- 中介层热阻优化:在 CoWoS 中介层中引入局部加厚铜布线与散热通孔(Thermal Via)阵列,将 HBM 与 SoC 产生的热量快速传导至散热盖,缩短热传导路径,中介层单位面积热阻较前代产品降低约三成;
- 液冷协同设计方案:针对 1000 瓦以上的高功耗场景,台积电推出 CoWoS 封装与液冷散热器的一体化设计规范,通过优化散热盖的流道接口与安装精度,使液冷散热器的冷板与散热盖紧密贴合。
未来技术演进:面向更高功率密度的封装散热方向
未来 AI/HPC 处理器的 TDP 有望在 2027 年前突破 2000 瓦,这将对封装散热技术提出更高要求。为此,台积电正在推进三大技术研发:
- 无界面层散热集成:探索将散热器直接与硅芯片表面键合的技术,消除 TIM1 的热阻损耗;
- 中介层材料革新:研发碳化硅(SiC)或氮化铝(AlN)基中介层,其导热系数较传统硅基中介层提升 5-8 倍,可大幅降低中介层的热阻贡献;
- 封装级主动冷却技术:在 CoWoS 封装内部集成微型蒸汽室或微型泵驱动的液冷回路,实现热量的主动传导与散逸,配合外部高效散热器,满足 2000 瓦级功耗的散热需求。
台积电强调,先进封装的散热技术已不再是单一的材料或结构优化,而是需要与芯片设计、系统冷却方案深度协同的系统性工程。通过封装与散热的一体化设计,将为 AI/HPC 领域的算力持续突破提供核心支撑。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。







