“钻石”也能冷却芯片
如今惊人的计算能力正让我们从人类智能迈向人工智能。随着机器的能力不断增强,它们不再仅仅是工具,更成为了塑造我们未来的决策者。但能力越大,发热也越严重!
当纳米级晶体管以千兆赫兹的速度切换时,电子在电路中高速移动,过程中会以热量形式损失能量,这就是笔记本电脑或手机发烫的原因。随着芯片上集成晶体管越来越多,有效散热的空间也随之减少。热量不再能在硅片上快速扩散,反而会积聚形成热点。这些热点的温度可能比芯片其他区域高出几十度。这种极端高温会迫使系统降低中央处理器(CPU)和图形处理器(GPU)的性能,以避免芯片性能退化。
换句话说,最初对微型化的追求,如今已演变成一场与热能的对抗。这一挑战存在于所有电子设备中。在计算领域,高性能处理器对功率密度的要求不断提高;在通信领域,数字和模拟系统都在推动晶体管输出更大功率,以实现更强的信号和更快的数据传输速率;而在用于能量转换与分配的电力电子设备中,热约束正不断抵消效率提升的成果。
与其任由热量积聚,不如从一开始就在芯片内部就将其分散开?就像把一杯沸水倒入游泳池中那样稀释热量。分散热量能降低最关键器件和电路的温度,还能让其他经过长期验证的冷却技术更高效地发挥作用。要实现这一点,我们必须在集成电路内部、距离晶体管仅几纳米的位置引入一种高导热材料,同时又不能破坏晶体管那些极为精密且敏感的特性。这时,一种意想不到的材料登场了——钻石。
从某些方面来看,钻石堪称理想之选。它是地球上导热性最好的材料之一,效率比铜高出许多倍,同时还具有电绝缘性。但将钻石集成到芯片中难度很大:直到最近,目前掌握的钻石生长技术都需要超过1000摄氏度的高温,而这个温度会损坏芯片电路。
不过,斯坦福大学研究团队已经实现了曾被认为不可能的突破,能在半导体器件表面直接生长出一种适合散热的钻石,且生长温度足够低,即使是先进芯片中最脆弱的内部互连结构也能承受。需要说明的是,这种钻石并非珠宝中常见的大型单晶体钻石,而是一种多晶涂层,厚度不超过几微米。
在早期测试的部分氮化镓射频晶体管中,添加钻石涂层后,器件温度降低了 50 多摄氏度。在更低的温度下,这些晶体管对 X 波段无线电信号的放大能力达到了之前的 5 倍。这种钻石对先进的互补金属氧化物半导体(CMOS)芯片而言将更为重要。研究人员预测,未来的芯片制造技术可能会让热点温度再升高近 10 摄氏度,如果研究能继续保持目前的进展,那么在 CMOS 芯片及其他电子设备中,热量将不再是一个难以应对的约束条件。
芯片中热量的产生与消散过程

当电流流动遇到电阻时,热量便会在晶体管以及连接晶体管的互连结构中产生。这意味着大部分热量都生成于半导体衬底的表面附近。之后,根据封装结构的不同,热量会要么穿过金属层与绝缘层,要么直接穿过半导体本身向上传导。接着,热量会接触到热界面材料,这类材料的作用是先将热量分散开来,随后热量最终会传递到散热器、散热片或某种液冷装置中,最终由空气或液体将热量带走。
如今主流的冷却方案,主要围绕散热器、风扇和散热片的技术改进展开。为了实现更优的冷却效果,研究人员还探索了多种方式:包括利用微流体通道进行液冷,以及使用相变材料散热。有些计算机集群甚至会将服务器完全浸没在具有导热性的绝缘液体中,这种液体不会导电。
这些创新无疑是重要的进步,但它们仍存在局限性。一方面,部分方案成本极高,只有用于性能最强的芯片时才划算;另一方面,有些方案体积过大,无法满足实际需求。此外,随着芯片架构逐渐向 “硅质摩天大楼” 演进,也就是将多层芯片堆叠在一起,现有的冷却方案都难以发挥有效作用。这类 3D 堆叠芯片能否实用,关键就在于能否将每一层芯片产生的热量都有效排出。
核心问题在于,芯片所用材料的导热性都较差,这导致热量被困在芯片内部并不断聚集,进而使芯片内部温度急剧升高。温度升高后,晶体管的漏电流会增大,造成电能浪费;同时,晶体管的老化速度也会加快。
散热片能让热量横向扩散,通过稀释热量帮助电路降温。但问题在于,散热片与热量产生的位置之间存在一定距离。因此对于这些热点,散热片的作用微乎其微。我们需要一种能在距离产热点仅几纳米处工作的散热技术。而这种新型低温钻石,恰好可能在这一领域发挥关键作用。
钻石的制备方法
在实验室将钻石研发方向转向散热材料之前,我们一直把它当作半导体材料来研究。单晶体形式的钻石,就像你手指上戴的钻戒钻石那样,具有宽禁带特性,还能承受极强的电场。单晶体钻石的导热率也位居所有材料前列,可达 2200 至 2400 瓦/(米・开尔文),大约是铜的 6 倍。多晶体钻石是一种更易制备的材料,当生长到一定厚度时,其导热率能接近单晶体钻石的水平。即便以多晶体形式存在,它的导热性能依然优于铜。
尽管钻石晶体管的前景看似诱人,但根据经验这背后还有很长的路要走。核心问题在于规模化生产。目前已有多家企业在努力将高纯度钻石衬底的尺寸扩大到 50 毫米、75 毫米甚至 100 毫米,但我们能从市场上买到的钻石衬底,直径仅约 3 毫米。
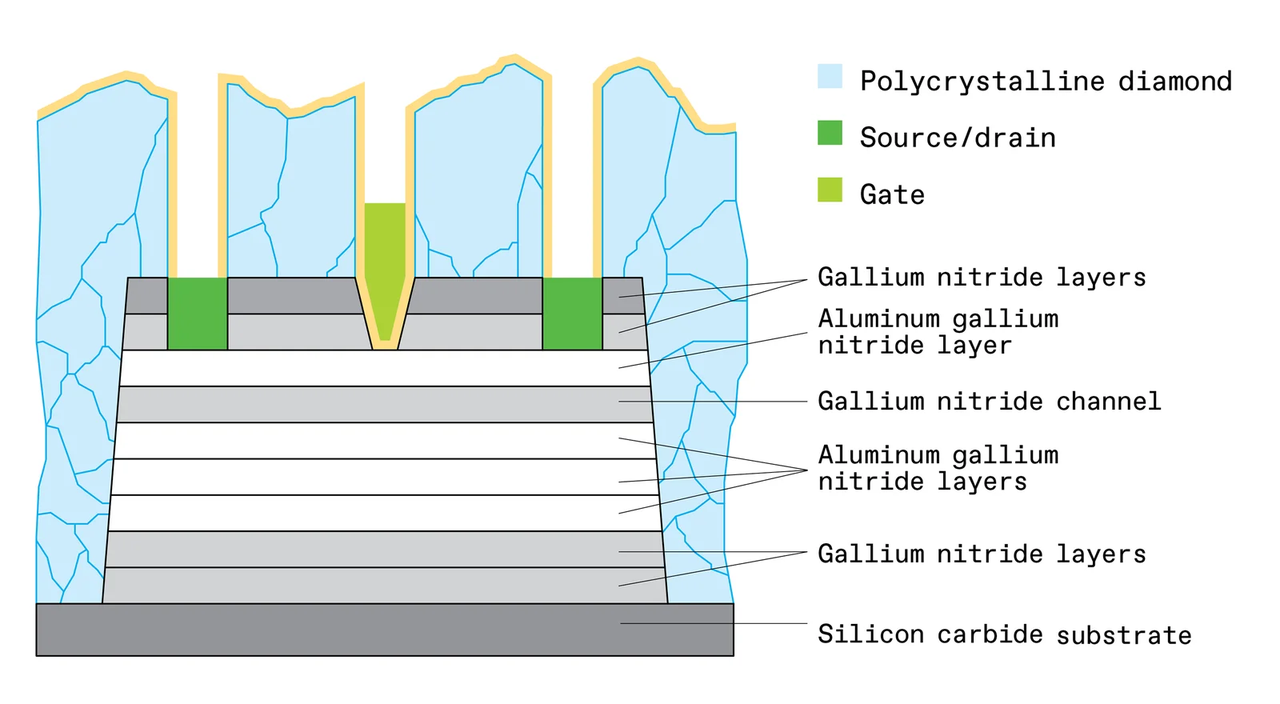
因此,转换思考,尝试在大型硅晶圆上生长钻石薄膜,希望借此向商业化规模的钻石衬底迈进。通常情况下,这种制备方法需要在 900 摄氏度甚至更高的高温下,让甲烷与氢气发生反应。反应生成的并非单晶体,而是一片由细小柱状体构成的 “森林”。随着这些纳米柱状体不断长高,它们会逐渐融合成均匀的薄膜,但要形成高质量的多晶钻石时,薄膜往往已经变得非常厚。这种厚膜生长会给材料带来应力,还常常导致开裂等问题。
但如果将这种多晶涂层用作其他器件的散热器呢?只要能让钻石在距离晶体管仅几纳米的位置生长,使其既能纵向又能横向散热,并且能与芯片中的硅、金属及绝缘材料无缝集成,它或许就能胜任这一角色。
钻石具有电绝缘性,且介电常数相对较低。这意味着它的电容效应很弱,因此通过覆盖钻石的互连结构传输的信号,衰减程度可能会很小。由此可见,钻石完全可以充当 “热绝缘材料”,即一种兼具电绝缘性与热传导性的材料。
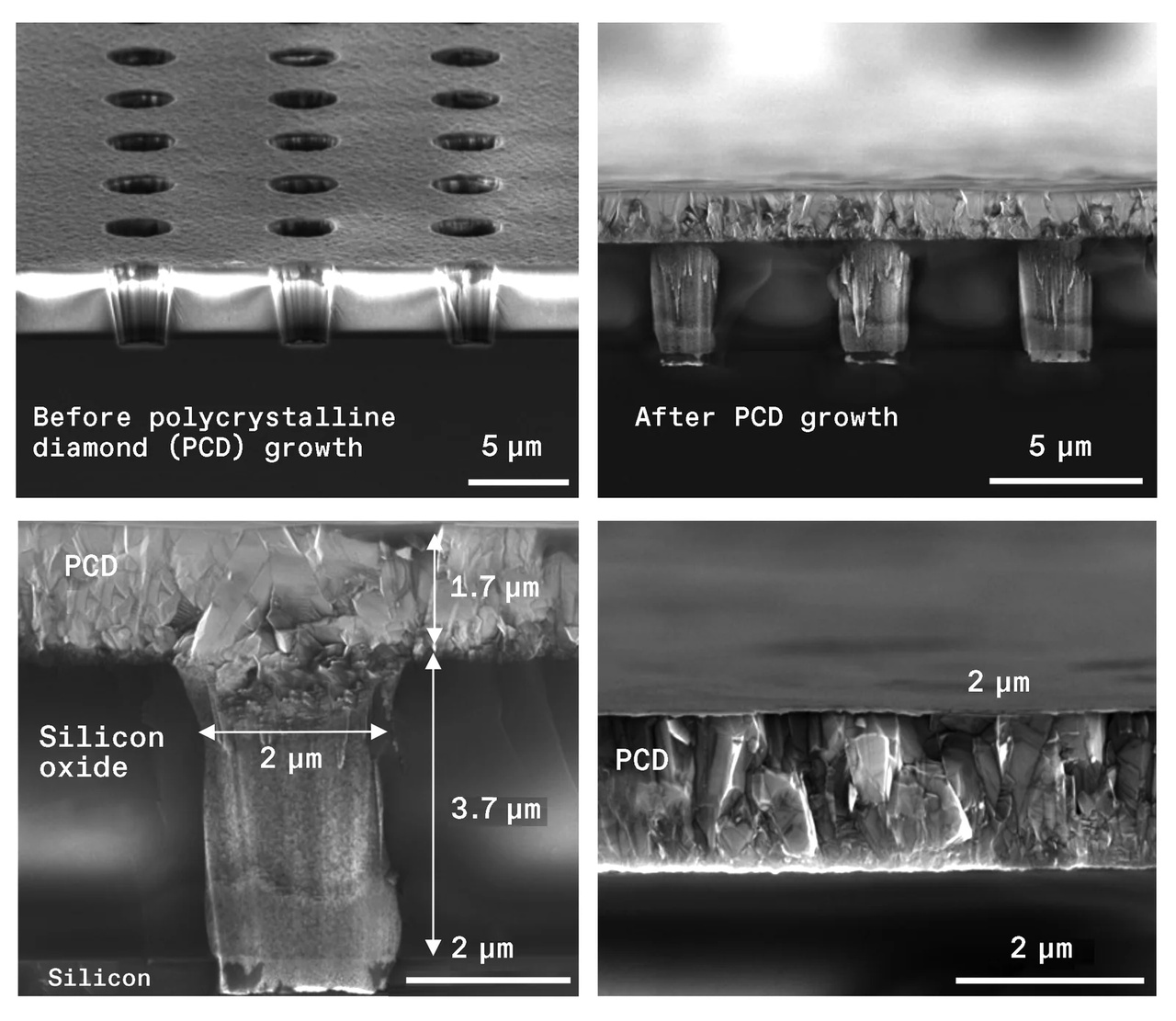
要让方案落地,就必须找到一种不同的钻石生长方法。首先,芯片内部没有足够空间容纳厚膜。其次,生长初期形成的细小尖状晶柱横向导热性很差,因此我们需要从一开始就培育大颗粒晶体,以实现热量的水平传导。第三是,现有钻石薄膜无法在器件侧面形成涂层,而这对本质上呈 3D 结构的器件至关重要。但最大的障碍还是生长钻石薄膜所需的高温,即便不直接烧毁集成电路的电路,也会对其造成损坏。我们必须将生长温度至少降低一半。
单纯降低温度是行不通的。研究发现,在反应混合物中加入氧气会有所帮助,因为氧气能持续蚀刻掉非钻石结构的碳沉积物。通过大量实验,终于找到了一种解决方案:在 400 摄氏度的温度下,就能在器件各个表面形成大颗粒多晶钻石涂层。这个温度对 CMOS 电路及其他器件来说是安全可承受的。
热边界电阻
尽管已经找到培育合格钻石涂层的方法,但还面临另一个关键挑战声子瓶颈,也被称为热边界电阻(TBR)。声子是热能的载体,就像光子是电磁能的载体一样。具体来说,声子是晶体晶格振动的量子化形式。这些声子会在不同材料的界面处堆积,阻碍热量传导。降低热边界电阻长期以来都是热界面工程领域的核心目标,常用方法是在界面处引入不同材料。但半导体只与特定材料兼容,这限制了选择范围。
在氮化硅包覆的氮化镓(GaN)材料上生长钻石时,研究团队观察到一个意想不到的现象:测得的热边界电阻(TBR)远低于此前文献报道的预期值。通过对界面科学与工程的深入研究,以及与德克萨斯大学达拉斯分校合作,找到了低 TBR 的成因。钻石与氮化硅界面处的相互扩散,会形成碳化硅(SiC)。这种碳化硅就像声子的 “桥梁”,能让热量更高效地传导。尽管这最初只是一项科学发现,但其技术影响立竿见影,有了碳化硅界面,器件的热性能得到了显著提升。
氮化镓高电子迁移率晶体管的首个测试案例
研究团队在氮化镓高电子迁移率晶体管(GaN HEMTs)中测试这种新型低 TBR 钻石涂层。这类器件通过控制其沟道内形成的二维电子气的电流,来放大射频(RF)信号。测试工作借鉴了加州大学圣塔芭芭拉分校乌迈什・米什拉实验室在 HEMT 领域的开创性研究。米什拉实验室研发出了一种特殊形态的材料,名为 N 极性氮化镓。他们研发的 N 极性氮化镓 HEMT 在高频下展现出卓越的功率密度,尤其在 W 波段(微波频谱中 75 至 110 吉赫兹的频段)表现突出。
这类 HEMT 之所以成为理想测试案例,核心原因在于其一个关键结构特点:控制器件电流流动的栅极,与晶体管沟道之间的距离仅几十纳米。这意味着热量会在非常靠近器件表面的位置产生,而钻石涂层若可能造成任何干扰,都会迅速在器件的运行中体现出来。
钻石层完全包裹住 HEMT,甚至覆盖器件侧面。通过将生长温度控制在 400 摄氏度以下,期望能保留器件的核心功能。尽管观察到器件的高频性能出现了一些下降,但热性能的提升十分显著,沟道温度大幅降低了 70 摄氏度。这一突破可能成为射频(RF)系统的变革性解决方案,使其能以比以往更高的功率运行。
钻石在 CMOS 芯片中的应用探索
这种钻石层是否也能应用于高功率 CMOS 芯片。在 CMOS 计算芯片领域,3D 堆叠似乎是提升集成密度、改善性能并突破传统晶体管缩放限制的最可行方向。该技术已应用于部分先进 AI 芯片,例如 AMD 的 MI300 系列;同时也在高带宽内存芯片中得到应用,这类内存芯片为英伟达 GPU 及其他 AI 处理器提供数据传输支持。这些 3D 堆叠结构中的多层硅片,大多通过微型焊球连接,在部分先进方案中则直接通过铜端子连接。要从这些堆叠结构中传输信号与电力,需要垂直铜互连,它们贯穿硅片,直至芯片封装的衬底。
3D 堆叠芯片的一个关键问题是堆叠内部会形成热瓶颈。对于 3D 架构,传统 2D 芯片所使用的散热器及其他散热技术已不足以满足需求。能否从每一层中有效散出热量,成为 3D 堆叠芯片实用化的关键。
在氮化镓(GaN)材料上开展的热边界电阻实验表明,类似的方法或许也能在硅材料中奏效。而当将钻石与硅集成时,结果十分显著:两者之间形成了一层碳化硅中间层,这使得钻石拥有了出色的热界面。
研究还提出了 “热支架”(thermal scaffolding)的概念。在这一方案中,厚度仅几纳米的多晶钻石层会被集成到晶体管上方的绝缘层内,以实现热量扩散。随后,这些钻石层会通过垂直导热体连接,这类导热体被称为 “热柱”(thermal pillars),材质可选用铜或更多钻石。这些热柱会与另一层散热器相连,而该散热器又会进一步连接到 3D 堆叠结构中下一个芯片的热柱,以此类推,直到热量传递至散热片或其他冷却装置。

研究团队通过模拟真实计算负载产生的热量,对一个概念验证结构进行了测试。该结构包含模拟双芯片堆叠中热点的虚拟加热器,以及钻石散热器和铜制热柱。测试结果显示,与未采用热支架的情况相比,该结构能将温度降至原来的十分之一。
目前仍有障碍需要克服。其中最关键的是,尚未找到使钻石涂层顶部达到原子级平整度的方法。不过,通过与行业合作伙伴及研究人员的协作,研究团队正在系统地研究这一问题及其他科技难题。这项研究有望为热管理领域开辟一条颠覆性的新路径,同时也是为未来高性能计算持续发展迈出的关键一步。
钻石散热解决方案的产业化推进
目前研究团队计划推动该技术与产业的融合,并且与美国国防高级研究计划局(DARPA)的 “Threads” 项目合作。该项目旨在通过器件级热管理技术,研发出功率密度比现有器件高 6 至 8 倍的高效、高可靠性 X 波段功率放大器。由于国防领域的应用对可靠性要求极高,因此钻石集成型 HEMT 正与行业合作伙伴共同接受严格测试。目前初步结果令人鼓舞。
但研究团队的愿景不止于氮化镓 HEMT,还包括其他材料,尤其是硅基计算芯片。在硅基芯片领域,研究团队已与台积电建立稳定合作;同时通过斯坦福 SystemX 联盟和半导体研究公司,正与应用材料公司、美光、三星等企业拓展新的合作机会。
若这项研究能取得成功,有望重新定义各行业的热管理标准。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。







