韩华半导体,开发晶圆间混合键合设备
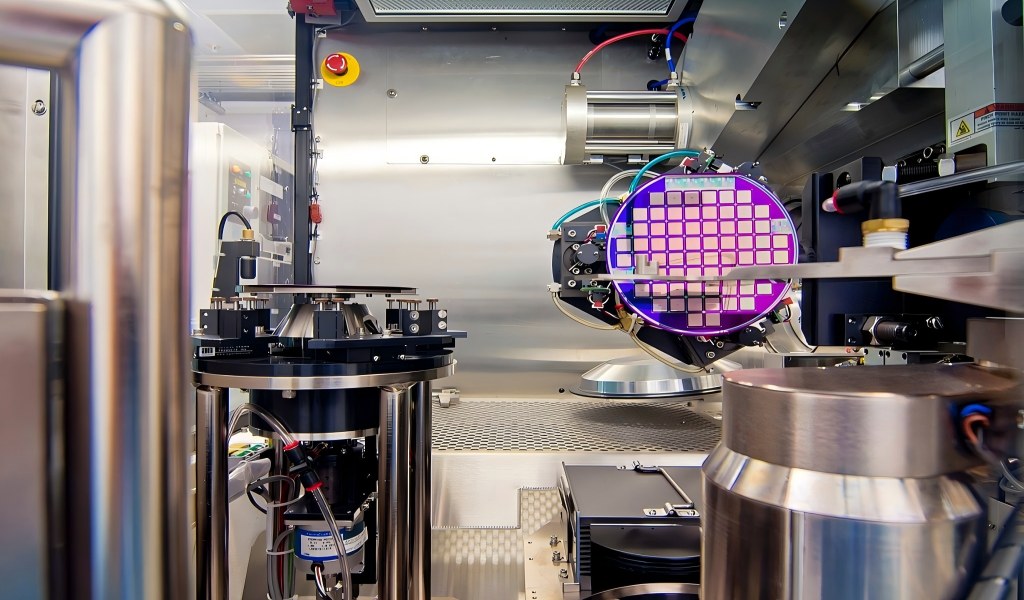
据报道,韩华半导体正在研发晶圆对晶圆(W2W)混合键合设备,旨在打造可同时支持半导体前道与后道工艺的产品阵容。该公司近期已确认研发第一代混合键合机,内部代号为SWB1。目前处于早期开发阶段,重点构建系统所需核心技术,上市时间尚未确定。
晶圆对晶圆(W2W)混合键合是一种将两片晶圆直接键合的先进半导体封装技术。其工艺流程为:在已形成电路图形的晶圆上制备二氧化硅(SiO₂)介质层,经蚀刻形成通孔,随后以铜填充通孔并通过化学机械抛光(CMP)实现平坦化。两片晶圆在室温下精准贴合后,介质层之间发生化学键合;后续经 200–400℃退火处理,铜原子相互扩散形成金属键合,完成电路互联。更短的互联长度可降低功耗与发热,同时提升数据传输速率。
韩华半导体计划将W2W混合键合设备供应至半导体前道制造环节,主攻逻辑芯片市场。该技术也可应用于背面供电网络(BSPDN),将信号布线置于晶圆正面,供电线路形成于晶圆背面,此类工艺需通过W2W键合粘贴载体晶圆以提供保护。目前市场龙头EV Group(EVG)设备的对准精度可达 ±50 纳米,韩华半导体相关负责人表示,公司已具备与头部厂商相当的精密控制能力。
韩华半导体切入W2W混合键合领域,被视为顺应该技术商业化节奏的布局。今年2月,公司已完成第二代混合键合设备SHB2 Nano的研发,该设备在荷兰生产并于上月运往韩国。该系统属于晶粒对晶圆(D2W)混合键合机,用于将单个晶粒贴装至晶圆之上,专为高层数高带宽内存(HBM)封装开发,而该领域传统上由热压(TC)键合设备主导。
SHB2 Nano由韩华半导体与荷兰企业Prodrive Technologies合作研发,并由后者在当地生产。一位熟悉研发情况的业内人士表示,实现这一精度需要高端元器件集成与超精密制造基础设施,受限于韩国本土超精密加工能力,韩华才选择与Prodrive Technologies合作。该人士称,混合键合设备需纳米级表面处理与组装,韩国因缺乏超精密制造基础,在这一环节仍面临挑战。
Prodrive Technologies是ASML供应商,为EUV光刻机提供直线电机、伺服驱动器等关键部件,可最大限度降低摩擦与振动,提升设备精度。该公司还提供合约制造服务(CMS),覆盖复杂机电系统的设计、原型开发、总装、功能测试与量产,并运营大型ISO 5级洁净室,即每立方米空气中0.5微米及以上颗粒数不超过3520个。
业内人士指出,韩华混合键合设备能否导入量产,取决于性能与成本竞争力。有项目知情人士称,SHB2 Nano 研发速度快于Prodrive常规周期,市场担忧设备完整性。此外,市场观察人士表示,与Prodrive合作开发,成本大概率高于本土自制。目前Besi混合键合设备单价约50亿—60亿韩元;业内估算,韩国国产混合键合设备定价或在40亿韩元左右,介于热压键合设备与Besi产品之间。
此外,混合键合在 HBM 中的落地时机仍存在不确定性。据悉,电子器件工程联合委员会(JEDEC)正讨论将 HBM 封装高度上限由此前 HBM4 的 775 微米放宽至 900 微米。额外的容差可能延长热压键合的生命周期,该技术采用微凸块与助焊材料,而非直接混合键合。
相比之下,前道应用的W2W键合市场已迎来增长。该技术已用于CIS与MEMS制造,三星电子为苹果供应的 CIS 产品也采用W2W混合键合,同时也应用于3D NAND闪存。近期,三星电子与SK海力士正考虑或计划在DRAM与HBM中采用W2W键合。
仁荷大学制造创新研究生院教授Joo Seung-hwan表示,海外厂商已掌握W2W键合技术并主导商用市场,韩国需加快W2W设备国产化进程,以保持半导体封装领域的竞争力。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。







