AI封装刚需爆发,新一代陶瓷基板登场
京瓷集团近日正式宣布,成功研发并将商业化一款全新多层陶瓷核心基板,该产品专为xPU(包含CPU、GPU等各类AI处理芯片)、交换级ASIC等高端半导体封装设计,将为快速演进的AI数据中心架构提供关键材料支撑。这款具备行业突破性的基板产品,将于2026年5月26日至29日在美国佛罗里达州奥兰多举办的ECTC 2026国际半导体封装技术大会上首次公开亮相,其独特的材料特性与技术优势,有望破解当前高端半导体封装领域的核心瓶颈。作为全球知名的精细陶瓷技术领军企业,京瓷此次推出的多层陶瓷核心基板,依托公司自主研发的精细陶瓷材料打造,核心聚焦高密度布线与超高结构刚性两大核心需求,旨在解决高性能半导体封装过程中普遍存在的形变(翘曲)问题,为芯片集成度与运算速度的持续提升提供底层保障。
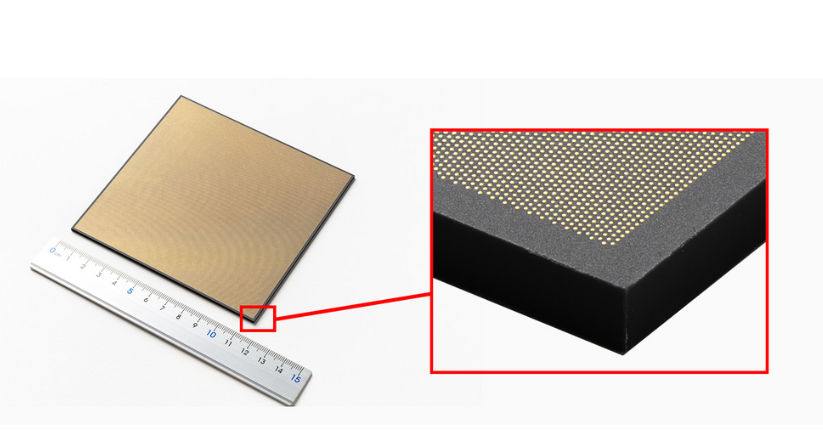
从行业发展背景来看,近年来生成式人工智能与大型语言模型的爆发式增长,正驱动全球范围内AI数据中心的大规模建设与升级,市场对高性能算力芯片的需求呈现指数级上升态势。尤其是xPU与ASIC这类核心运算芯片,为了承载更复杂的计算任务、实现更高的处理效率,其封装形式正朝着更大尺寸、更高密度的方向演进,2.5D封装技术已成为高端算力芯片的主流选择。所谓2.5D封装,是指通过高密度中介层(中继基板),将多颗集成电路芯片并排布局,借助精细电路图案与垂直层间布线技术,大幅提升芯片之间的数据传输速度与整体运算性能,这种封装架构对基板的性能提出了极为严苛的要求。然而,传统采用有机材料制作的核心基板,在应对大尺寸封装需求时,逐渐暴露出明显的性能短板:一方面,有机材料的结构刚性不足,在芯片封装、焊接及后续使用过程中容易发生翘曲变形,严重影响芯片的封装良率与长期运行可靠性;另一方面,有机基板的布线微缩化能力有限,难以满足高端芯片对高密度布线的需求,成为制约芯片性能进一步突破的关键瓶颈。正是在这一行业痛点下,京瓷凭借在精细陶瓷材料领域数十年的技术积累,针对性地研发出这款多层陶瓷核心基板,为高端半导体封装提供了全新的解决方案。
这款多层陶瓷核心基板的核心优势首先体现在超高刚性带来的抗形变能力上。与传统有机基板相比,京瓷采用的专有精细陶瓷材料具备更为优异的结构稳定性与机械强度,能够有效抵抗封装过程中各环节产生的应力,最大限度减少基板的翘曲变形。根据京瓷2026年2月完成的仿真测试结果显示,该陶瓷基板在相同尺寸条件下,形变程度远低于有机基板,这一特性不仅能显著提升大尺寸半导体封装的良率,还允许采用更轻薄的基板设计,在缩小芯片整体体积的同时,进一步优化散热效率与电性能表现。对于需要集成多颗芯片的2.5D封装方案而言,基板的低翘曲特性尤为重要,它能确保芯片与基板、基板与电路板之间的连接稳定性,降低因形变导致的接触不良、信号衰减等问题,为高端算力芯片的稳定运行提供坚实保障。
其次,多层陶瓷结构赋予了该基板卓越的精细布线能力。在半导体基板中,层间导电通道(即导通孔)的加工精度直接决定了布线密度与信号传输效率。京瓷创新地采用了陶瓷未烧结(软化)阶段成型工艺,在陶瓷材料仍具备一定柔韧性时完成导通孔的制作,相较于传统有机基板采用的机械钻孔工艺,这种加工方式能够实现更小的导通孔直径与更紧凑的孔间距。更精细的导通孔设计,使得基板能够承载更高密度的三维布线,有效提升了芯片内部及芯片之间的信号传输速度,同时减少了信号干扰与能量损耗,完美适配了高端AI芯片对高密度互连的需求。这一技术突破,不仅解决了传统有机基板布线密度不足的问题,还为未来芯片封装向更高集成度、更快运算速度发展预留了充足的技术空间。
此外,该基板还具备高度的定制化适配能力与前置仿真服务优势,能够更好地满足不同客户的个性化需求。在产品设计阶段,京瓷可根据客户提供的芯片性能指标、封装工艺要求等关键参数,提供全面的热性能、电性能及基板翘曲仿真分析服务。通过精准的仿真模拟,客户能够在实际生产前优化设计方案,提前规避潜在的技术风险,大幅降低研发试错成本,缩短产品从设计到量产的周期。这种“定制化设计+前置仿真”的服务模式,体现了京瓷在半导体封装材料领域的综合服务能力,也使得该陶瓷核心基板能够更好地适配不同类型、不同应用场景的高端半导体产品,进一步扩大了其市场应用范围。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。







