砸38.7亿美元!SK海力士赴美建2.5D封装产线
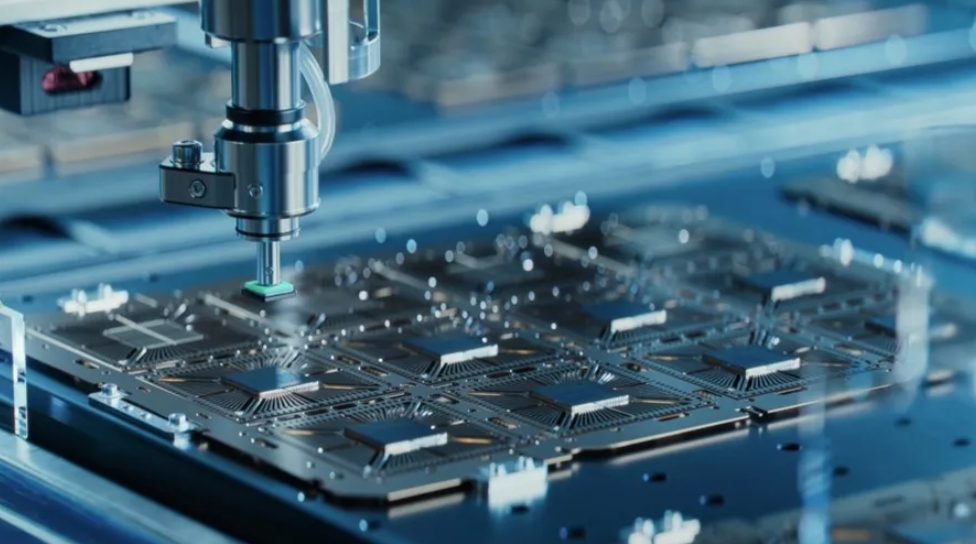
随着人工智能(AI)浪潮席卷全球,半导体产业的竞争核心正从单纯的芯片制造,转向更为复杂的先进封装技术。根据媒体报道,韩国存储器大厂SK海力士(SK hynix)正在采取一项具备战略意义的重大投资,计划在美国建立其首条2.5D 封装量产线。此动作不仅象征着SK 海力士要超越HBM(高频宽存储器)供应商的角色,更展现其欲掌握最先进封装技术主导权、强化AI 半导体供应链地位的雄心。
根据ZDNet Korea的报道,SK海力士目前正深入讨论在其位于美国印第安纳州西拉法叶(West Lafayette)的新建封装工厂中,导入2.5D 制造产线的方案。这座工厂是SK海力士在美国境内的首座生产基地,定位为AI 存储器专用的最先进封装生产基地。而且,该投资案规模庞大,SK海力士先前已宣布将投入38.7 亿美元进行建设,目标是在2028 年下半年正式投入营运。
目前,2.5D 封装技术被视为整合HBM 与高性能系统半导体(如GPU 或CPU)的核心制程之一。其技术原理是在半导体芯片与电路板(Substrate)之间插入一层被称为“硅中介层”(Silicon Interposer) 的薄膜。而这项技术具备透过硅中介层缩短芯片间的传输距离,大幅优化电力消耗与数据处理速度,以提升效能与电力效率的优势。尤其,目前全球AI 芯片大厂英伟达(Nvidia)的高性能AI 加速器,便是透过2.5D 封装技术将HBM 与高性能GPU/CPU 紧密整合而成,更显示出相关市场潜力。
SK海力士认为,若能掌握2.5D 封装的量产能力,将能全面强化其在AI 半导体封装领域的竞争力,而不仅仅局限于HBM 的生产。现阶段,SK海力士虽然在韩国国内具备2.5D 封装的基本技术力与研发设备,但仍不足以支撑能对应大型系统级封装(SiP)的量产需求,因此,报道引用消息人士的说法指出,由于现有设施难以负荷整合了HBM 的大规模AI 加速器生产,因此SK海力士正积极与封装合作伙伴商讨,在美国西拉法叶工厂建立正式的量产线。
报道强调,SK海力士预计投资能带来以下好处:
确保供应稳定性: HBM 在交付最终客户(如英伟达)前,必须通过2.5D 封装的品质测试(Qual Test)。在现有架构下,即使HBM 本身没有问题,若在封装过程中发生不良,将导致整个交货过程延误。
厘清责任归属: 2.5D 封装构造复杂,一旦出现不良品,往往难以精确判定责任归属于存储器厂商或封装厂。
挑战台积电的垄断地位:目前AI 加速器所需的2.5D 封装市场事实上由台积电(TSMC)独占。 SK海力士若能成功建立量产线,将能向客户提供HBM 与封装一站式的统包(Turn-Key)服务,提升议价能力与市场占比。
半导体业界分析人士指出,SK海力士已将“具备自有的2.5D 封装设备”视为极其重要的战略课题。一旦技术趋于稳定且高度化,SK海力士将不满足于单纯的内部研发,而是会正式以此作为一项独立业务进军市场。另外,这项在美国的投资计划,不仅是为了应对英伟达等大客户的需求,更是为了在未来次世代HBM 竞争中抢占先机。随着2028 年工厂完工,全球AI 半导体供应链预计将迎来一场剧烈的权力重组,而SK海力士正试图从一名强力的组件供应商,进化为掌握核心整合技术的产业关键节点。
什么是2.5D封装?
2.5D/3D 是将多个集成电路集成到同一封装内的封装技术。在 2.5D 结构中,两个或多个有源半导体芯片并排放置在硅中介层上,以实现极高的芯片间互连密度。在 3D 结构中,有源芯片通过芯片堆叠的方式集成,以实现最短的互连线和最小的封装尺寸。
近年来,2.5D 和 3D因其在实现极高的封装密度和高能效方面的优势,已成为理想的芯片集成平台。
2.5D/3D IC封装主要用于集成以下应用中的HBM:高端GPU;高端FPGA;用于数据中心和 5G 基础设施的网络交换机/路由器;用于人工智能训练的人工智能加速器。在芯片时代,2.5D 和 3D IC 封装将在 CPU、移动 AP、硅光子学、显示驱动 IC 等众多应用中发挥越来越重要的作用。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。






