先进封装,必争之地
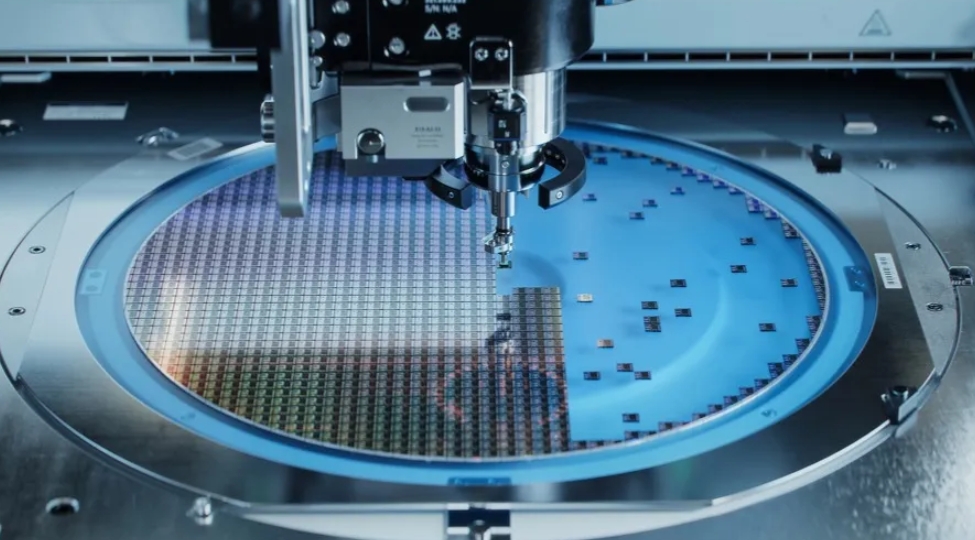
随着人工智能革命加速推进至2025年末,业界关注的焦点已从芯片的晶体管数量转向支撑这些晶体管的复杂架构。尽管大规模语言模型(LLM)对计算能力的需求空前高涨,但主要的瓶颈不再仅仅是处理器的速度,而是“内存墙”——即数据在内存和逻辑之间传输速度的物理极限。先进封装技术已成为解决这一危机的关键方案,它从制造过程中的次要步骤转变为半导体创新的核心前沿。
此次转型的核心是Kulicke and Soffa Industries。该公司已成功转型,从传统引线键合领域的领导者跃升为人工智能先进封装领域的关键参与者。KLIC通过实现高带宽内存(HBM)和芯片组架构所需的复杂堆叠和互连,证明人工智能性能的未来不仅取决于芯片设计者,更取决于封装技术大师。
利用无磁通TCB技术突破内存壁垒
2025 年人工智能硬件的技术挑战在于从二维布局向 2.5D 和 3D 异构架构的过渡。传统的引线键合技术使用细金线或铜线将芯片连接到封装上,但这种技术越来越无法满足英伟达 Blackwell 系列等人工智能 GPU 的超高速需求。这些现代加速器需要数千个被称为微凸点的微小连接,且精度需达到 10 微米以下。正是在此背景下,KLIC 的先进解决方案部门,特别是其 APTURA™系列产品,显得至关重要。
KLIC 的突破性技术是无助焊剂热压键合 (FTC)。与使用化学助焊剂去除氧化物的传统方法(该方法会在 HBM4 所需的小间距下留下难以清除的残留物)不同,KLIC 的 FTC 技术采用原位甲酸蒸汽。这种“干式”工艺可确保更清洁、更可靠的键合,从而实现小至 8 微米的互连间距。这种精度对于 12 层和 16 层 HBM 堆叠至关重要,这些堆叠可提供下一代 AI 训练所需的 4TB/s 以上的带宽。
此外,KLIC 还推出了 CuFirst™混合键合技术。传统的键合方式需要加热和加压来熔化焊球,而混合键合技术则允许在室温下实现铜对铜互连,之后再进行介质密封。这种“无焊球”方法显著缩短了数据传输距离,与上一代产品相比,延迟和功耗最多可降低 40%。通过提供这些工具,KLIC 正在帮助业界突破传统硅芯片尺寸缩放的物理极限,这一趋势通常被称为“超越摩尔定律”。
驾驭CoWoS 供应链
先进封装技术的战略重要性在世界领先的晶圆代工厂台积电的供应链中体现得淋漓尽致。到2025年底,台积电的晶圆基板封装(CoWoS)产能已成为科技界最宝贵的资源。为了满足英伟达和AMD的需求,台积电将其CoWoS产能翻番至每月约8万片晶圆,而符合这些生产线要求的设备供应商的市场地位也因此得到巩固。
KLIC已成功跻身这一精英行列,其无助焊剂TCB系统已通过台积电CoWoS-L工艺认证。这使得KLIC与ASMPT和BE Semiconductor Industries等现有厂商展开直接竞争。尽管ASMPT在更广泛的市场中仍保持着高产量领先地位,但KLIC专注于无助焊剂技术,使其成为满足AI服务器模块高良率、高可靠性要求的首选合作伙伴。对于NVIDIA等公司而言,拥有像KLIC这样多家合格的设备供应商,能够确保更具韧性的供应链,并有助于缓解2023年和2024年困扰整个行业的长期短缺问题。
这一转变也使AMD受益,该公司在采用3D芯片架构方面一直更为积极。AMD今年早些时候推出的MI350系列采用3D混合键合技术,将计算芯片直接堆叠到I/O芯片上。这种架构选择使AMD在能效方面拥有竞争优势,而能效对于数据中心运营商而言,其重要性已与原始速度不相上下。随着这些科技巨头争夺人工智能领域的霸主地位,他们对先进封装设备供应商的依赖实际上已使KLIC等公司成为了人工智能时代的“军火商”。
超越摩尔定律
先进封装技术的兴起标志着半导体行业格局的根本性转变。几十年来,半导体行业一直遵循摩尔定律,通过缩小单个晶体管的尺寸,每两年晶体管密度翻一番。然而,随着晶体管尺寸接近原子尺度,进一步缩小尺寸的成本和复杂性也急剧上升。先进封装技术提供了一种摆脱这种经济困境的方法,它允许工程师将芯片“分解”成更小、更专业的芯片单元,这些芯片单元可以在不同的工艺节点上制造,然后再拼接在一起。
这一趋势具有深远的地缘政治意义。在美国《芯片法案》以及欧洲和日本类似举措的推动下,将封装能力迁回西方国家已成为新的关注焦点。历史上,封装被视为利润低、劳动密集型的“后端”工序,通常外包给东南亚。而展望2026年,封装被视为高科技、高利润的“中端”工序,对国家安全和科技主权至关重要。KLIC作为一家总部位于美国、业务遍及全球的公司,拥有得天独厚的优势,能够从这一回流趋势中获益。
此外,人工智能对环境的影响正受到密切关注。处理器与其内存之间数据传输所需的能量往往超过实际计算所需的能量。通过使用KLIC的先进键合技术将内存更靠近逻辑电路,业界在“绿色人工智能”领域取得了显著进展。降低互连的寄生电容不再仅仅是一个技术目标,而是全球最大数据中心运营商可持续发展的必然要求。
通往玻璃基板和CPO之路
展望2026年和2027年,先进封装技术的发展路线图将带来更加根本性的变革。其中最令人期待的发展之一是从有机基板转向玻璃基板。玻璃具有更优异的平整度和热稳定性,这对于人工智能芯片尺寸越来越大、温度越来越高至关重要。像KLIC这样的公司已经开始研发能够满足玻璃独特处理和粘合要求的设备,因为玻璃比目前使用的材料脆性更大。
另一个重要的发展方向是共封装光器件(CPO)。由于电信号在长距离传输中难以保持完整性,业界正致力于将光纤直接集成到芯片封装中。这将使数据能够通过光而非电进行传输,从而几乎消除“内存墙”,并使大量GPU集群能够像单个巨型处理器一样运行。这些光纤的对准精度比当今最先进的TCB(热控制芯片)还要高一个数量级,这代表着KLIC工程团队面临的下一个巨大挑战。
专家预测,到2027年,也就是“HBM4元年”,混合键合技术将从小众应用领域走向大规模生产。虽然TCB仍然是目前Blackwell和MI350芯片的主要生产工艺,但向混合键合的过渡需要新一轮的巨额资本投入。最终的赢家将是那些能够在高产量工厂环境中提供高吞吐量、同时保持亚微米级精度的设备的企业。
半导体组装的新时代
Kulicke & Soffa 从一家引线键合专家转型为先进封装巨头,这正是半导体行业整体变革的一个缩影。随着人工智能模型日益复杂,“封装”的重要性已与“芯片”不相上下。如今,堆叠、连接和冷却这些庞大硅系统的能力,已成为决定谁能引领人工智能竞赛的关键因素。
此次进展的关键要点包括:无助焊剂键合在提高HBM4良率方面发挥着至关重要的作用,以及获得台积电CoWoS供应链认证的战略意义。展望2026年,业界将密切关注玻璃基板的首次大规模应用以及混合键合技术的持续普及。
对于投资者和行业观察人士而言,信息很明确:未来十年人工智能的突破不仅仅体现在代码或芯片上,更体现在将它们连接在一起的微观铜互连层中。先进的封装技术不再是流程的最后一步,而是构建人工智能未来的基石。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。







