EDA工具重新定义3D封装
根据Yole市场数据,先进封装市场正以年复合增长率10%的速度成长,预计2027年达572亿美元。 IDTechEx更预测,Chiplet技术的市场总价值将在2035年达到4110亿美元。 然而,这场技术革命的成败关键并不在制造端,而在于能否突破设计工具的根本性限制。

Yole预测,整体先进封装市场规模将在2027年达到572亿美元
EDA工具正从幕后的辅助角色跃升为先进封装发展的决定性因素。 EDA产业地图显示,单颗AI芯片设计需要调用超过50种EDA工具,比传统芯片增加了300%。
这现象反映的是设计复杂度的几何级增长:当不同制程节点的芯片需要整合在同一封装中,当热管理和机械应力成为关键设计变量,当系统级协同优化成为必要条件时,传统EDA工具的设计逻辑已经无法应付。
西门子EDA技术经理王志宏表示:从AI技术在EDA工具中的深度整合,到系统级协同设计方法论的建立,再到平台化趋势对产业生态的重新定义,新一代EDA技术正在重构先进封装的可能性边界。
设计复杂度跃升,传统工具面临三重挑战
王志宏深入剖析了EDA工具在先进封装领域遭遇的技术瓶颈。 第一重挑战来自设计复杂度的指数级提升。 传统单芯片设计虽然复杂,但最终仍是同一制程节点的产物。 如今在2.5D、3D IC、Chiplet封装中,每个组件都是独立制程的产品,还要加上不同材质的中间层,设计路径的复杂度比过往提升了至少10倍。
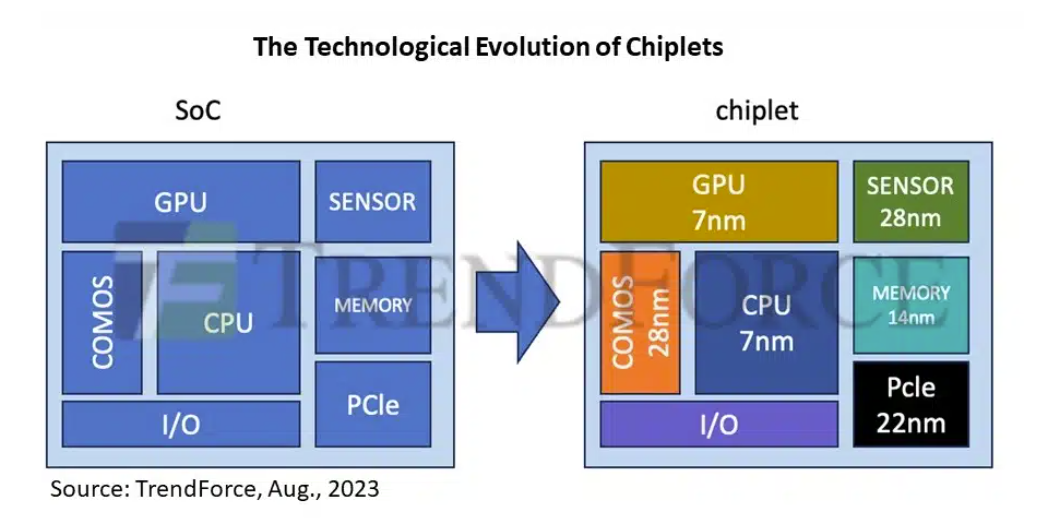
chiplet从传统单一制程转换为多芯片封装,设计难度提升了至少十倍
第二重挑战源于多物理域问题的集中爆发。以前一颗芯片的热会往上散出,现在把它堆叠在一起时,上面的芯片会被挡住。此外,硅中间层与不同材质间的机械应力问题,在3D堆叠环境下变得极其复杂。热管理和机械应力已从次要考量跃升为设计成败的关键因素。
第三重挑战是验证复杂度的几何级增长。传统芯片设计的验证工具Calibre,面对跨芯片、跨材质、跨封装层级的复杂架构时,规则撰写的复杂度呈现爆炸性增长。王志宏坦言引导工程师去做这件事情的复杂度会变很高。这会直接拖慢设计周期,推高了开发成本。
Intel Ponte Vecchio GPU的成功案例印证了这些挑战的现实性。这颗集成47个不同Chiplet的处理器,从设计到量产耗时超过四年,其中EDA工具的适配和验证就占了近三分之一的时间。 这样的开发周期在AI芯片竞赛中几乎是致命的。
系统级协同设计,AI技术成突破关键
面对这些挑战,芯片设计理念正发生根本性转变:从序列设计转向并行设计。过去的方法是在最后阶段进行验证和仿真,一旦发现问题就要回头重来,迭代效率极低。新的设计概念要求设计与验证并行,在每个阶段都引入验证和模拟,确保无误后再进入下一阶段。
AI技术的深度整合正在重新定义EDA工具的能力边界。西门子最新的AI平台,用最简单的概念来解释就是懂EDA语法的ChatGPT。这个平台能够自动处理复杂的Calibre语法生成,将原本需要资深工程师数周完成的工作压缩到数小时。
热仿真工具的技术革新同样令人瞩目。早期的热仿真主要针对系统层级,如服务器或PCB模块。现在这些工具必须深入到IC层级,精确分析3D堆叠结构中每个芯片的热行为。透过芯片布局优化和散热路径设计,工程师能够在设计早期就解决热管理问题,避免后期的重大修改。
讯号完整性分析也迎来了突破。王志宏指出,因为之前都在单芯片里面做,现在会跨芯片还有跨不同的材质。 新的分析工具集成了芯片级和系统级的信号分析能力,通过实体与频率的防范技术,将信号网络分析的精度提升了30%以上。
平台化整合趋势,产业生态迎来重组
西门子EDA的平台化策略,是以Innovator 3D IC作为中控台,整合从系统技术协同优化到具体实现的全流程。 这个平台能够同时处理硅芯片、中间层、封装基板甚至PCB和BGA的优化设计。王志宏特别提到了成本效益:有时候上方的Bump稍微排列得好一点,就可以用比较少的层数,这种优化能够直接影响中间层的制造成本。
2025年2月18日,西门子与台积电的最新合作案例证明了这种平台化趋势的重要性。西门子为台积电InFO封装技术提供经认证的自动化工作流程,采用Innovator3D IC驱动的先进封装整合解决方案。
Chiplet技术的快速发展正在重新定义产业合作模式。这个庞大市场背后,EDA工具的重要性愈加凸显。 王志宏认为Chiplet的模块化优势能够大幅降低设计风险,他表示,很多常用的方式可以把它做成模块,运用这些早就已经tape out过或验证过的模块,重复利用。
王志宏预测未来五年将出现几个关键技术趋势:晶粒整合将加速发展; 高密度3D基层技术将更广泛应用; 硅光子技术将走向成熟; Chiplet将实现大规模商业化应用。 每一个趋势都需要EDA工具的深度配合和创新突破。
四大技术趋势成形,EDA产品创新势在必行
面对这场3D封装革命,中国台湾半导体产业需要在2025年下半年前完成关键布局。 因此产业界有三个方向需要重视:第一,加速培养熟悉先进封装设计的EDA人才,预计需求将在未来两年内增长300%; 第二,支持本土EDA工具商在多物理域仿真领域的技术突破,这是打破国际垄断的最佳切入点; 第三,推动产学合作建立3D封装设计的标准化流程,中国台湾有机会在这个新兴领域制定游戏规则。
当摩尔定律的传统路径逐渐走向终点,王志宏认为透过2.5D、3D IC和先进封装技术,让半导体的发展可以延续某种频率,这个曲线比较不会被传统的技术瓶颈所局限。 更重要的是,系统级优化将成为未来竞争的关键,不仅只是芯片设计的系统,还考量芯片设计完之后,它放到PCB板上,PCB板上放到服务器上,我们可以一路从芯片设计到整个系统,去做一个最完整的模拟验证。
这种全方位的系统级思维,是未来半导体产业和EDA工具发展的核心方向。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。




