博通公布尖端3.5D XDSiP技术,预计2026年量产
博通刚刚宣布其全新 3.5D eXtreme Dimension 系统级封装 (XDSiP) 平台技术,该技术使消费类 AI 客户能够开发下一代定制加速器 (XPU)。
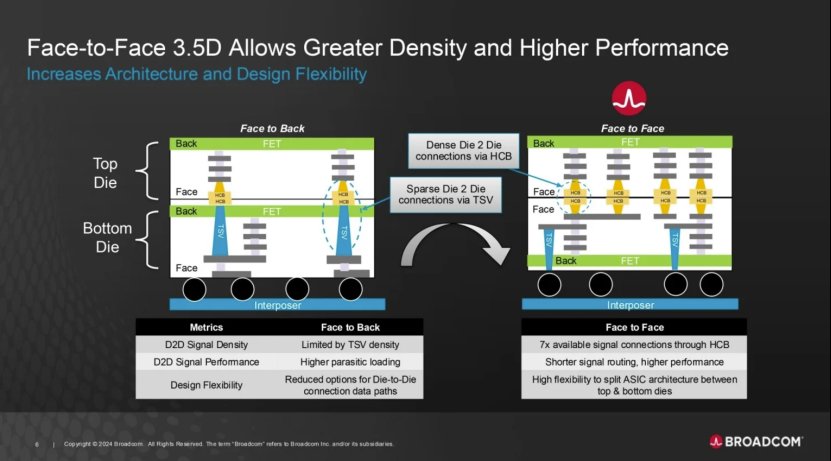
全新 3.55D XDSiP 在单个封装中集成了超过 6000 平方毫米的硅片和多达 12 个 HBM 堆栈,可实现大规模 AI 的高效、低功耗计算。博通表示,通过开发和推出业界首款 Face-to-Face (F2F) 3.5D XPU,它已实现这一重要里程碑。
Broradcom 解释道:“训练生成式 AI 模型所需的巨大计算能力依赖于 100,000 个至 100 万个 XPU 的大规模集群。这些 XPU 需要越来越复杂的计算、内存和 I/O 功能集成,以实现必要的性能,同时最大限度地降低功耗和成本。摩尔定律和工艺扩展等传统方法难以满足这些需求。因此,先进的系统级封装 (SiP) 集成对于下一代 XPU 至关重要。”
该公司继续说道:“在过去十年中,2.5D 集成(涉及在中介层上集成多达 2500 平方毫米的多个芯片和多达 8 个 HBM 的 HBM 模块)已被证明对 XPU 开发很有价值。然而,随着新的和越来越复杂的 LLM 的推出,它们的训练需要 3D 硅堆叠,以获得更好的尺寸、功率和成本。因此,将 3D 硅堆叠与 2.5D 封装相结合的 3.5D 集成有望成为未来十年下一代 XPU 的首选技术”。
据悉,博通目前正在采用该技术开发五款产品,预计将于2026年2月开始生产。
Broadcom 3.5D XDSiP 的主要优势
增强的互连密度:与 F2B 技术相比,堆叠芯片之间的信号密度提高了 7 倍。
卓越的功率效率:通过使用 3D HCB 代替平面晶粒到晶粒 PHY,将晶粒到晶粒接口的功耗降低 10 倍。
降低延迟:最大限度地减少 3D 堆栈内计算、内存和 I/O 组件之间的延迟。
紧凑的尺寸:可实现更小的中介层和封装尺寸,从而节省成本并改善封装翘曲。
博通高级副总裁兼 ASIC 产品部总经理 Frank Ostojic 解释道:“随着我们达到摩尔定律的极限,先进封装对于下一代 XPU 集群至关重要。通过与客户密切合作,我们基于台积电和 EDA 合作伙伴的技术和工具创建了 3.5D XDSiP 平台。通过垂直堆叠芯片组件,博通的 3.5D 平台使芯片设计人员能够为每个组件搭配合适的制造工艺,同时缩小中介层和封装尺寸,从而显著提高性能、效率和成本。”
台积电公司业务发展与全球销售高级副总裁兼副联席首席运营官张文忠博士补充道:“过去几年,台积电与博通密切合作,将台积电最先进的逻辑工艺和 3D 芯片堆叠技术与博通的设计专业知识结合在一起。我们期待将这一平台产品化,以释放 AI 创新并实现未来增长”。
富士通高级副总裁兼先进技术开发主管 Naoki Shinjo 表示:“富士通与博通已合作十余年,已成功将多代高性能计算 ASIC 推向市场。博通最新的 3.5D 平台使富士通下一代 2 纳米 Arm 处理器 FUJITSU-MONAKA 能够实现高性能、低功耗和更低成本”。
如今,随着摩尔定律放缓,通过制程升级提高晶体密度的方法性价比越来越低,先进封装重要性愈发凸显。先进封装通过创新封装手段实现芯片更紧密的集成,优化电气连接,满足了人工智能、高性能计算等技术发展对芯片性能的要求。
随着高端消费电子、人工智能、数据中心等应用领域迅速发展,对先进封装的依赖日益提升。在先进封装细分领域中,FCBGA、FCCSP和2.5D/3D封装技术于2024年成为市场主流。目前,英伟达、AMD等主流AI芯片企业大多依赖台积电的3nm制程和CoWoS封装工艺。而随着AI需求的爆炸性增长,台积电的生产线2025年的部分产能目前已被预订,这将导致价格上涨。
据悉,英伟达产能需求占2025年整体CoWoS供应量比重仍达五成。与此同时,AMD、微软、亚马逊、谷歌、英特尔等对CoWoS的需求有增无减,先进封装市场需求快速增长。台积电董事长魏哲家曾表示,客户对CoWoS先进封装需求远大于供应,尽管今年增加CoWoS产能超过2倍,仍供不应求。
为了满足客户需求,一方面台积电在积极扩产。据报道,台积电计划明年在全球范围内新建10家工厂,将专注于2nm制程工艺和晶圆上芯片封装(CoWoS)技术。其中先进封装工厂有3座,包括将收购的群创AP8液晶面板工厂改造成封装工厂和在嘉义科学园区新建封装工厂。
另一方面,台积电将溢出订单由矽品、日月光等封测厂分担,这些分包商已启动WoS环节或CoW环节的产能扩增项目,其中多家先进封装巨头传出扩产计划。
近期,日月光控股、台积电、英特尔、三星、通富微电、华天科技、甬矽电子、晶方科技等半导体龙头企业先后宣布投入资源,布局先进封装相关技术与扩充产能,这些项目的应用均指向高性能计算和AI等领域。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。







