新型高性能二维半导体材料研发获突破
国防科技大学和中国科学院金属研究所联合研究团队在新型高性能二维半导体晶圆级生长和可控掺杂领域取得重要突破,有望为后摩尔时代自主可控的芯片技术提供关键材料和器件支撑。相关成果近日在线发表于国际顶级期刊《国家科学评论》。
如果把芯片比作“城市”,晶体管就是里面的“房子”。当晶体管沟道微缩至10纳米以下时,意味着“房子”密度太高,“城市”已经非常拥挤。这会导致“短沟道效应”和“功耗墙”两大问题,“短沟道效应”容易导致电流“乱跑”,“功耗墙”则导致芯片越来越烫、耗电越来越大。这两个问题捆在一起,让传统硅基芯片的性能很难再获突破,摩尔定律逼近物理极限,探索新的半导体芯片材料迫在眉睫。
据介绍,原子级厚度的二维半导体因迁移率高、带隙可调、栅控能力强,被视为后摩尔时代芯片材料的核心候选。然而,晶格缺陷诱导的自发电子掺杂和费米能级钉扎效应,使现有二维半导体材料体系长期呈现N型材料多、P型材料少,以及N型材料性能好,P型材料性能差的结构性失衡问题。
论文通讯作者、国防科技大学前沿交叉学科学院朱梦剑研究员表示,“芯片里的晶体管需要N型和P型配对工作,高性能P型材料的缺失已成为制约亚5纳米节点二维半导体发展的关键,也是国际半导体领域激烈竞争的科学技术制高点。”
针对上述问题,研究团队建立了以液态金/钨双金属薄膜为衬底的化学气相沉积方法,实现了晶圆级、掺杂可调的单层WSi2N4薄膜的可控生长。其研发的新方法将畴区尺寸提升至亚毫米级,生长速率较已有文献报道值高出约3个数量级。
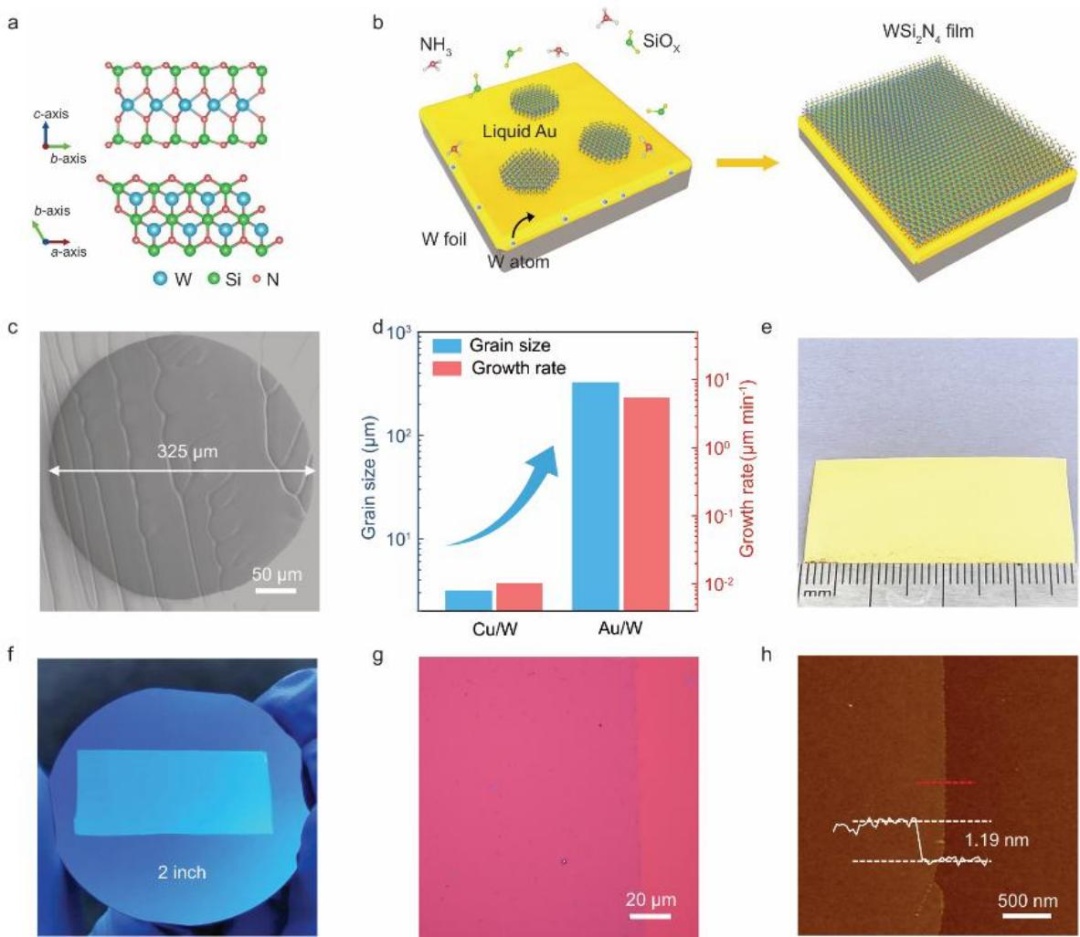
化学气相沉积法生长单层WSi2N4半导体薄膜
在器件性能方面,该方法具有掺杂浓度可调的独特优势,通过原位缺陷工程有效调控载流子掺杂浓度,使其在5.8×1012cm-2至3.2×1013cm-2范围内连续可调。值得关注的是,该材料还兼具优异的化学稳定性,综合性能在同类二维材料中表现突出。

单层WSi2N4场效应晶体管的电学性能
研究结果表明,单层WSi2N4作为新型高性能P型沟道材料,在二维半导体CMOS集成电路中具有广阔的应用前景。更重要的是,这种以液态金为生长衬底的化学气相沉积策略,为其他 MA₂Z₄型材料的快速生长提供了一种通用且高效的途径。研究采用液态 Au/Mo/Re 复合衬底,成功实现了高质量单层 MoSi₂N₄的快速生长;由于 Mo 在液态 Au 中的溶解度远高于 W,因此在 Re 箔上沉积了超薄 Mo 层以避免 Mo 原子过量供给。在 30 分钟内即可获得横向尺寸约 145 μm 的单层 MoSi₂N₄晶体,对应生长速率约4.83 μm·min⁻¹,约为已有报道中固态 Cu/Mo 衬底上 MoSi₂N₄生长速率(~0.64 μm·min⁻¹)的8 倍。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。







