绕过顶级EUV,晶圆一哥的底牌终于摊开
当半导体行业掀起High-NA EUV光刻机抢购热潮时,台积电似乎并没有这项计划,甚至表示:直至 2029 年的全系列规划节点,涵盖 A12、A13 等核心制程,均不纳入High-NA EUV设备的应用计划。
那么,不靠这台“光刻神器”,台积电又将如何破解未来芯片微缩的核心难题?
台积电最新路线图:两大赛道,三个“王炸”节点
当地时间4月22日,全球晶圆代工龙头台积电(TSMC)在美国加州圣塔克拉拉市举行了2026年北美技术论坛。
台积电业务发展及全球销售高级副总裁兼副首席运营官张晓强博士在会上宣布将实施新的工艺技术发布策略:每年为客户端应用推出一款新节点,每两年推出一款面向高负载AI和高性能计算(HPC)应用的新节点。
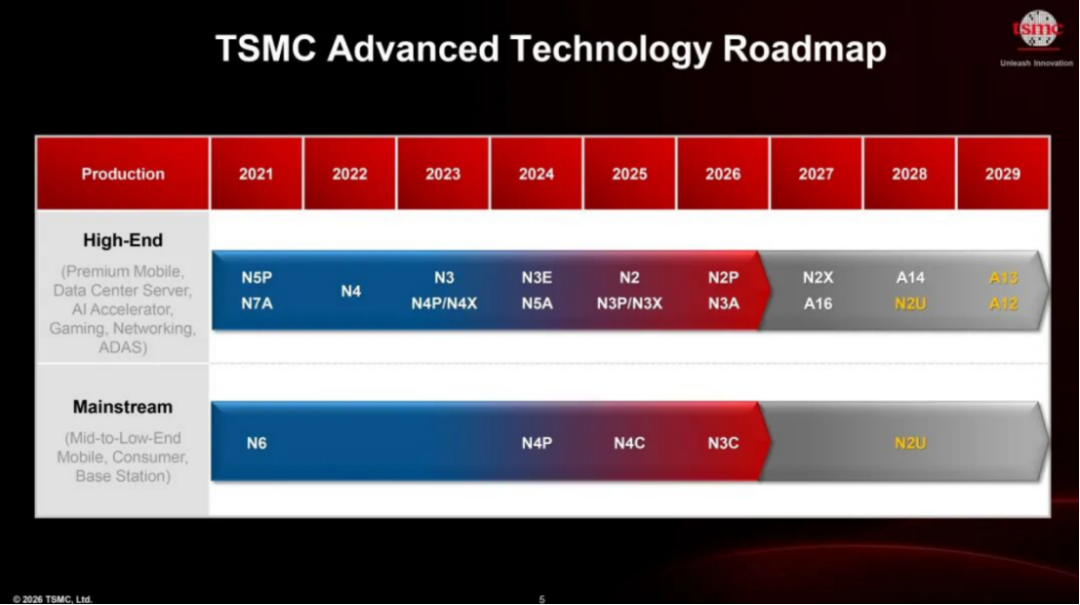
其中面向智能手机、消费电子等客户端的节点包含N2、N2P、N2U、A14、A13。这类节点强调成本、能效和IP复用,强大的设计兼容性至关重要,客户可接受渐进式改进。
其中N2U制程是N2平台的第三代延伸版本。N2U同样利用DTCO技术,在N2P的基础上提供进一步优化:在相同功耗下性能提升约3%-4%,或在相同速度下功耗降低8%-10%,逻辑密度提升2%-3%。
A14是台积电首个非过渡型1.4纳米级工艺,将于2027年底启动风险性试产,2028年下半年完成大规模量产。 A13工艺则被定义为A14的“光学微缩版”。它并非一次彻底的重构,而是通过设计-技术协同优化(DTCO),在保持与A14完全兼容的设计规则和电气特性的前提下,实现约6%的面积缩减。A14、A13走兼容优化、渐进升级的路线,兼顾成本与能效。
面向AI/HPC数据中心的节点包含A16、A12。这类场景对算力需求极致严苛,技术路线以性能提升为核心,对成本敏感度相对较低,需通过显著的技术迭代证明工艺过渡的价值。
A12将采用第二代纳米片晶体管技术,并集成超级电轨(SPR)背面供电技术。该工艺专为AI(人工智能)和HPC(高性能计算)应用场景打造,旨在通过在正面和背面同时进行微缩,实现整体密度的显著提升,以满足数据中心对算力的极致渴求。
随着A13与A12于2029年投入量产,这也标志着半导体制造将正式跨入“亚纳米”时代。值得关注的是,尽管台积电已突破2nm以下工艺壁垒,却迟迟未将 High-NA EUV 设备纳入产线规划。台积电敢于做出这一决策的底气何在?背后又暗藏着怎样的产业逻辑?
对比三星、英特尔:路线不同,差距已现

根据三星公布的制程路线图显示,计划于2027年量产1.4nm工艺。不过去年市场消息称三星已暂时推迟从第二季度开始在平泽 2 号工厂部分建造 1.4nm 代工测试线的计划。对 1.4nm设施的投资已推迟到去年年底或最早今年上半年。由于测试线建设的推迟,或许量产时间会再推迟。
关于High-NA EUV的应用情况,三星电子于2025年3月率先安装首台High-NA EUV光刻机用于1.4纳米芯片生产,同年斥资1.1万亿韩元引进两台EXE:5000型号设备,计划在2025年底和2026年初分别交付一套,用于其2nm制程的全面生产,其中一套将部署在华城厂区,另一套则可能部署在泰勒晶圆厂。
此外,三星还宣布启动1nm芯片研发,预计2029年后实现量产,旨在通过颠覆性技术突破追赶台积电。
英特尔CEO陈立武在CES 2026期间透露,公司正大力进军14A(1.4nm)制程工艺,并已向部分客户提供PDK,或已有外部客户。值得注意的是,4月23日,马斯克在特斯拉财报电话会上披露了TERAFAB芯片工厂项目的核心落地细节。该项目确定采用Intel 14A(1.4nm级)先进制程工艺,计划在2027年至2029年间建成自有产能并实现规模化量产。目前,双方正就技术授权及具体合作条款进行沟通。
根据英特尔此前晶圆代工蓝图显示,Intel 10A(1nm制程)将于2027年底投入生产/开发(非量产),标志着该公司首个1nm节点的到来。
关于High-NA EUV的应用情况,英特尔首席财务官(CFO)David Zinsner在花旗 2025 年全球 TMT 大会上表示,下一代的Intel 14A制程技术将是英特尔为代工客户从头开始设计第一个尖端制造工艺,因为其将使用ASML最新的0.55NA(数值孔径)的High-NA EUV光刻机Twinscan EXE:5200B。
如此来看,三星是最早开始使用High-NA EUV光刻机的公司。
2nm→1.2nm,台积电为何敢弃用High-NA EUV?
High-NA EUV是ASML推出的“下一代光刻设备”,被行业称成“解决1nm节点光刻难题”的神器。这也意味着越早的使用High-NA EUV,便越早的将芯片制造的主动权交给ASML。台积电之所以能明确暂缓导入该设备,显然已经有了足够的应对办法。
第一点,EUV的“二次开发”。
要知道EUV作为先进制程的核心装备,各晶圆厂购入后并非简单使用,台积电、三星、英特尔基于各自的工艺与技术储备,演化出不同的技术路线。
首先,在计算光刻领域,台积电率先联合英伟达将cuLitho平台投入生产,利用GPU加速将光学邻近效应修正(OPC)速度提升40倍以上,显著缩短工艺迭代周期。三星则专注于OPC模型的精细化与光刻胶轮廓预测,积累了大量的核心专利。
其次,先进工艺的制造并不只是依赖EUV 光刻机这一台机器即可,配套的所有设备、材料等都需要进一步升级。
有业内人士指出,EUV光刻机相较传统的深紫外(DUV)光刻机,光罩及保护膜等都须进一步调整,保护膜一直是半导体制程中防止尘粒污染的关键保护机制。而且,进入EUV光刻时代后,过去广泛使用的有机Pellicle,因无法兼具透光率与稳定性,已不再适用。目前EUV制程大多采用“无pellicle”的光罩,导致必须频繁进行图样检查。 一旦发现缺陷,不仅需修复或重制光罩,生产成本也大增并降低速度。因此,包括ASML等半导体业者近年也投入EUV光罩保护膜的研发,但由于技术难度高,尚未实现量产。
自2019年以来,台积电通过自身的系统级优化及自研EUV光罩保护膜材料,EUV生产晶圆产量累计增加30倍,同时电力消耗也减少24%。台积电甚至计划改造一座200毫米工厂来专门生产自研EUV光罩保护膜,性能甚至超过了ASML原厂供应的EUV光罩保护膜。
最后,多重曝光能力是另一分水岭。据悉,所谓的四重自对准曝光方案(SAQP)技术,实际上是以英特尔为首的半导体巨头在十年前引进的,并且在14纳米到7纳米关键节点推进时普遍采用的临时替代性方案。 但是由于其本身具有的高度复杂性和良率问题,导致英特尔马失前蹄,被率先导入EUV光刻机的台积电和三星赶超。
在7nm时代,由于EUV技术尚不成熟,台积电便继续使用成熟的深紫外光刻(DUV)设备,并通过多重曝光技术来实现精细电路。三星选择了截然不同的路径,在7nm节点就率先引入了全新的EUV设备。其初衷是用更高波长的单一光源,大幅简化制造流程,从而降低复杂度和光罩数量。因此,在多层曝光技术上,台积电的掌握似乎更扎实一些。
第二点,GAAFET技术,不抢“先机”。
随着FinFET架构在3nm节点触及物理天花板,漏电失控、性能与功耗失衡成为行业共性痛点,而GAAFET(环绕栅极)技术,成为延续摩尔定律的唯一路径。但台积电并未像三星、英特尔那样急于抢跑,而是选择“稳扎稳打”,反而实现了后发制人。
三星是最早官宣量产GAAFET的厂商,其在2022年就已宣布将在3nm节点引入该技术,并于2025年先于台积电量产了2nm GAA器件。看似抢占了技术先机,但冒进的布局也带来了后遗症:三星3nm GAA工艺良率问题频发,性能表现也不及预期,导致谷歌、高通等客户因良率和能效问题,将代工订单转交给台积电。
英特尔将GAAFET技术命名为RibbonFET,在其18A工艺中得到第一次应用。该制程技术已于2026年1月应用于首款消费级产品酷睿Ultra 3系列(代号Panther Lake)处理器。2026年3月,英特尔表示将考虑开放18A制程对外代工。
台积电的策略则更为务实:在3nm制程中继续沿用FinFET技术,核心原因是其仍有技术红利可挖——通过工艺优化,既能满足市场对性能和功耗的需求,又能保证良率稳定、成本可控。而GAAFET的制造难度呈指数级上升,纳米片堆叠、高k/金属栅极环绕、刻蚀与沉积精度要求远超FinFET,不仅良率爬坡慢,更会大幅增加生产成本。这种“不冒进、不盲从”的布局,让台积电在GAAFET技术上实现了“稳扎稳打”。
第三点,把光刻的“难”,转移出去。
除了上述两项核心技术,台积电还通过“光刻+刻蚀+沉积”的协同微缩,将光刻的难度转移到刻蚀、沉积等环节。
原子层刻蚀(ALE)是一种高度可控的刻蚀技术,通过分步化学反应逐层去除材料,每次仅刻蚀一个或几个原子层。与传统等离子刻蚀相比,ALE的关键区别在于其自限性(self-limiting)特性,即每一步反应在达到预设条件后自动停止,确保刻蚀深度精确可控。
ALE工艺通常分为两个步骤:首先通过化学吸附在材料表面形成反应层,随后利用物理或化学手段选择性去除该层。例如,在刻蚀硅时,可先用氯气进行表面钝化,再通过离子轰击去除反应产物。这种分步操作使得ALE在3D结构(如FinFET、GAA晶体管)的加工中表现出色,尤其适合高深宽比结构的精密刻蚀需求。
在台积电 2nm、1.6nm(A16)乃至 1.2nm(A12)等更先进制程的量产攻坚中,原子层刻蚀绝非辅助工艺。区别于传统干法刻蚀的“粗放式”加工,ALE 以原子级精准控制为核心优势,每次循环仅去除约 0.1–1nm 的材料厚度,完美适配台积电 GAA 纳米片晶体管架构的严苛要求。同时,ALE 具备极佳的全域均匀性,可将晶圆表面粗糙度控制在 0.3nm 以内,工艺性能较传统干法刻蚀提升三倍以上。
本质上,台积电的策略并非“放弃光刻”,而是通过协同微缩,将自己的优势领域发挥到极致,弥补了不使用High-NA EUV的短板,同时避开了ASML的技术垄断与天价成本陷阱。
要知道单台 High-NA EUV 光刻机定价高达 3.5 亿欧元,折合近 4 亿美元,相较现有量产 EUV 机型成本实现翻倍。台积电创始人张忠谋也曾公开评价,新一代 High-NA EUV 设备具备极高的采购与落地成本。
据悉,台积电已将中长期毛利率目标锁定至 56% 以上,相较于过往 50% 的基准目标形成显著抬升。毛利率数个百分点的波动,将直接转化为每年 50 亿至 100 亿美元的利润差额,成本端的刚性上涨会直接冲击其盈利预期。
此内容为平台原创,著作权归平台所有。未经允许不得转载,如需转载请联系平台。







