CPO量产,卡在关键一环
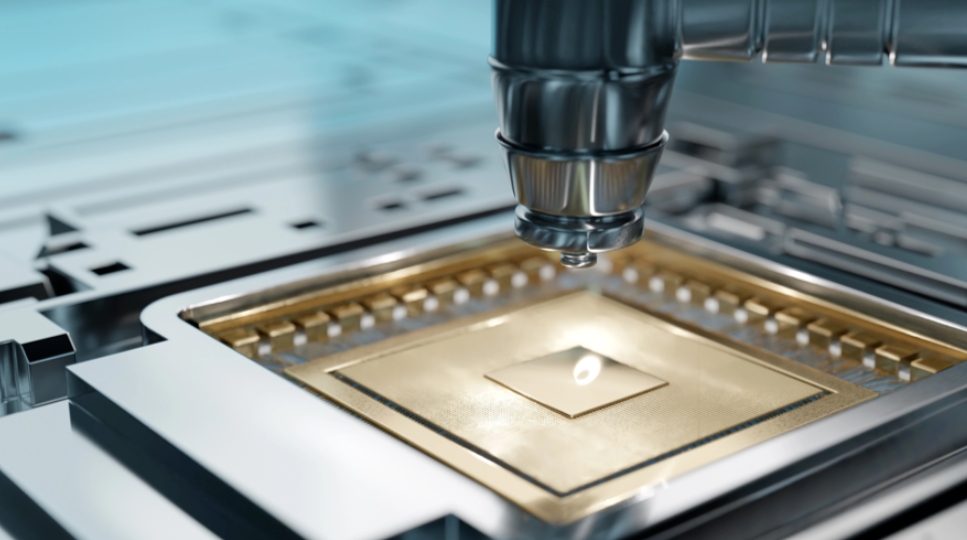
在全球人工智能基础设施加速落地、高速数据传输需求呈指数级增长的背景下,硅光半导体技术凭借其高带宽、低功耗、抗干扰的核心优势,已成为支撑 AI 算力系统、先进光电共封装(CPO)及下一代高速通信基础设施的关键核心技术。然而,当行业全力推进硅光技术从实验室原型走向规模化量产时,半导体测试供应链正遭遇前所未有的严峻阻碍 —— 测试环节的技术断层与设备短板,已成为制约产业落地的核心瓶颈。行业向硅光与光电共封装技术转型的过程中,芯片集成度提升、信号传输速率突破、多物理场协同测试等各类技术难题交织,大幅增加量产落地阻力。据集邦咨询(Digitimes)最新行业报告显示,当前半导体测试供应链不仅需承接传统电子芯片的测试需求,更要全权负责人工智能算力系统及配套全系列功耗测试体系的研发与落地工作,测试场景的复杂度与技术门槛较传统半导体提升数倍。
芯片测试的最大瓶颈集中在二级接入节点(Insertion 2) 这一关键环节。业内专家普遍认为,Insertion 2 是连接芯片设计验证(Insertion 1)与量产最终测试(Insertion 3)的核心枢纽,其技术成熟度直接决定硅光芯片能否实现商业化落地,也是目前阻碍硅光技术从实验室测试阶段迈向规模化量产的核心症结。与 Insertion 1 聚焦设计规则验证、Insertion 3 侧重成品良率筛选不同,Insertion 2 需要面对芯片堆叠集成后的多维度测试需求,既要验证电路功能的完整性,又要保障光子信号传输的稳定性,同时还需兼顾功耗控制与可靠性检测,测试维度的多元化导致技术难度呈几何级数增长。
二级接入节点的测试困境,根源在于头部晶圆代工厂的先进集成架构设计,尤以台积电系统整合芯片(SoIC) 垂直堆叠方案的大规模应用最为典型。该技术通过晶圆级键合工艺,实现电子集成电路(EIC)与光子集成电路(PIC)的垂直堆叠集成,使芯片在有限空间内实现更高集成度与性能提升,但也为测试环节带来了颠覆性挑战:此类堆叠芯片需进行双面同步测试,测试过程中既要保证底层电子电路正常通电运行,精准采集功耗、时序等关键参数,又要严格做到全光路关闭,避免光子信号干扰电子电路的测试结果,这种 “电通光断” 的矛盾性测试需求,对设备的同步控制精度提出了苛刻要求。更关键的是,目前全球市场尚未出现可同时适配两种信号工况的自动化测试设备 —— 现有测试系统要么仅能满足单一电路测试需求,要么无法实现光、电信号的隔离控制,导致测试过程需通过人工切换设备、分步测试完成,不仅使测试耗时较传统芯片增加 3-5 倍,更因人工操作误差、环境干扰等因素导致测试故障率居高不下。对半导体厂商而言,二级接入节点已成为成本与效率的 “无底洞”:单颗芯片的 Insertion 2 测试成本较传统芯片高出 2-3 倍,而测试良率却普遍低于 80%,若无法快速实现测试成本优化与效率规模化提升,行业整体对硅光技术的研发与投产热情将持续降温,甚至可能延缓整个 AI 基础设施的升级进程。
为突破量产瓶颈、满足市场对硅光芯片的迫切需求,全球主流测试设备与接口厂商正加倍投入研发资源,通过技术合作与联合攻关的方式双线推进技术迭代。作为全球半导体测试设备的两大龙头企业,爱德万(Advantest)与泰瑞达(Teradyne)已率先布局,分别联合佛吉富(FormFactor)、汉民测试(Hanmin Test)等专注于高频、高精度接口技术的专业企业深度绑定,形成 “测试设备 + 接口方案” 的协同研发模式,共同攻克硅光测试的核心技术壁垒。其中,爱德万联合佛吉富推出的Triton 光子测试解决方案,已率先为一级接入节点(Insertion 1) 建立起统一的光子集成电路测试通用标准,该方案通过定制化的探针卡与测试模块,实现了光子芯片关键参数的精准测量,目前已在部分高端光子芯片设计公司中得到应用。泰瑞达则聚焦于 CPO 封装后的集成测试方案,其与汉民测试合作开发的高速光电协同测试系统,可实现对封装后芯片的光功率、插入损耗、眼图等参数的快速检测。值得注意的是,现阶段一级接入节点(设计验证)与三级接入节点(量产终测)均已形成成熟的自动化测试流程与行业标准,测试良率稳定在 95% 以上,唯有二级接入节点始终处于技术空白状态,缺乏统一的测试协议与自动化设备,成为整个测试供应链的 “卡脖子” 环节。
行业分析机构进一步指出,随着 AI 算力需求向更高性能、更低延迟演进,光电共封装(CPO)技术作为解决传统封装传输瓶颈的关键方案,其封装作业的风险等级已达到极高水平。CPO 技术将光模块与芯片封装集成一体,使信号传输距离缩短至毫米级,大幅提升传输速率与能效,但也导致封装过程中任何微小缺陷都可能造成整个芯片失效,且缺陷发现时间越晚,修复成本越高 —— 数据显示,封装完成后发现的缺陷修复成本,是设计阶段发现缺陷的 10-20 倍。因此,行业普遍推行左移测试(Shift Left Testing) 理念,将测试环节提前至芯片设计与晶圆制造阶段,通过分阶段验证的方式,在每个生产节点排查潜在缺陷。企业普遍采用 “设计验证 - 晶圆级测试 - 封装前测试 - 封装后测试” 的全流程验证方案,以此规避先进芯片设计带来的高额良品损耗、保障利润空间。但即便如此,Insertion 2 环节的技术缺失仍导致左移测试无法完全落地,部分潜在缺陷难以在早期被发现,最终影响产品良率与可靠性。
供应链业内人士进一步警示,若行业在未来 1-2 年内仍无法攻克通电测试与无光测试的设备技术短板,测试厂商或将被迫采取高风险的设备调试与检测方案。在 AI 基础设施建设工期紧张、市场需求迫切的双重压力下,为保障交付周期,部分企业可能在量产初期选择直接跳过二级接入节点测试以压缩工期,将测试压力完全转移至 Insertion 3 阶段。这种妥协式操作虽能短期满足交付需求,但将导致三级接入节点的成品缺陷率大幅飙升 —— 数据模拟显示,跳过 Insertion 2 测试后,Insertion 3 的缺陷率可能从原本的 5% 上升至 20% 以上,不仅会增加后期筛选成本,更可能因产品可靠性问题引发终端应用故障,对企业品牌与行业信任造成不可逆的影响。这一行业现状充分印证:高速传输环境的稳定性与精准度,是未来人工智能算力基础设施高质量发展的核心关键,而 Insertion 2 测试技术的突破,已成为决定硅光产业能否规模化落地的 “生死线”。
目前,行业内已形成共识:解决 Insertion 2 测试难题需要全产业链协同发力 —— 晶圆代工厂需开放更多芯片设计接口与测试规范,测试设备厂商需加快自动化、高精度测试系统的研发,接口厂商需突破高频、低损耗的探针与连接技术,同时行业协会需推动测试标准的统一制定。只有通过跨企业、跨领域的技术合作与资源整合,才能逐步填补 Insertion 2 的技术空白,实现硅光测试成本与效率的平衡,最终为 AI 基础设施的持续升级提供稳定可靠的核心支撑。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。





