液冷救了GPU,却苦了周边芯片?
液冷技术在冷却高功率芯片(例如GPU)方面效果显著,但却给附近其他芯片带来了散热问题,这些芯片原本受益于用于冷却GPU的气流。如今气流消失,如何有效散发PCB板上的剩余热量成为一大挑战。
冷却系统能够确保组件在规格范围内运行,同时提升电路板和组件的可靠性。“温度始终是可靠性的重要指标,”西门子数字化工业软件创新路线图经理 Robin Bornoff 表示,“温度本身并不会导致故障,它始终是一种后续的热机械现象。某个部件温度升高后会发生弯曲,如果弯曲过度就会断裂。一旦断裂,C4 凸点(或其他部件)就会损坏,最终导致整个电路失效。”
气流可以到达电路板的每个部分,浸没式冷却也是如此。更常见的是,采用液冷来对发热芯片进行策略性冷却。不适合液冷的芯片可能需要额外的被动或主动冷却。这就催生了微冷却的概念,即针对有限空间,仅冷却一个或几个组件的冷却方案。
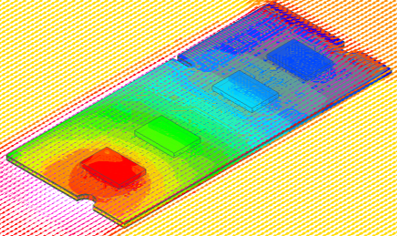
图 1:此电路板热模拟图显示,强制空气从右上角吹入。如果改为液冷,蓝色和红色芯片的温度可能会降低,但中间的芯片(如果未接触到液冷)可能会变成红色。来源:Synopsys
在缺乏气流的情况下,必须对电路板上的所有组件进行分析,以识别任何新的散热问题。针对这种情况,确实存在替代解决方案。“在缺乏主动散热的情况下,可以使用诸如均热板和热管之类的替代技术,” Synopsys公司电子产品热完整性高级产品经理 Jeff Tharp 表示。
基本的散热计算
传统上,电路板作为一个整体进行冷却,通过足够的空气流通来保证板上的元件在其规定的温度范围内运行。确定空气流量需要了解所有热源,以确保充分的冷却。
“要确定温度值,你需要知道温度的产生速率和散失速率,”萨普解释说。“当这两个速率达到平衡时,就确定了工作温度。”
但这些电路板通常包含几个主要的发热元件和许多其他组件。为了便于讨论,我们可以将需要液冷的芯片称为“热芯片”,将不需要液冷的芯片称为“温芯片”(如果它们接近过热极限)或“冷芯片”(如果它们远未过热)。虽然我们通常更关注热芯片,但在模拟整个电路板的散热性能时,其他芯片(无论温芯片还是冷芯片)的散热影响都会被考虑在内。而采用风冷散热,所有组件都能从中受益。
如果冷却分析只关注发热芯片,那么冷却方法可能对它们有效,但对周围发热的组件则不足。在缺乏空气流通的情况下,发热的芯片可能会变成过热的芯片。那么,这是否意味着它们也必须采用液冷呢?也许是,但并非必然如此。
电路板整体交互
电路板上任意一点的温度取决于各个组件产生的热量以及散热方式。热量产生通常取决于组件的负载。因此,散热才是真正需要调整的参数,因为降低负载是最后的手段,会降低电路板功能的效用。
散热会受到相邻发热源的影响。例如,如果 HBM 内存堆叠与发热的 GPU 相邻,其散热难度会比没有 GPU 时更大。对电路板进行整体分析时,应考虑这些组件之间的相互作用,以确定合适的空气流通方案。
Synopsys 产品营销总监 Marc Swinnen 表示:“在进行温度分析时,我们可以计算出芯片的功率(瓦特)。但瓦特是一个速率,而不是温度。因此,实际产生这种热量速率的温度取决于环境。但这有点像先有鸡还是先有蛋的问题,因为芯片的功率取决于其温度,而温度又取决于功率,所以需要反复计算几次。”
因此,关键问题在于所有冷却装置是否都是为特定电路板量身定制的,还是有些芯片在采购时就已经集成了冷却系统。专为液冷设计的芯片可能在制造过程中就已单独安装了冷却装置。诸如冷板之类的技术可以在电路板组装过程中安装,并根据特定电路板进行定制,但例如直接冲击式冷却则需要能够畅通无阻地接触到硅芯片。如果在芯片制造完成后再进行冷却,则会使硅芯片在晶圆厂和组装厂之间暴露于损伤或杂质之中。
在这种情况下,散热装置的安装可能仅基于芯片自身的散热特性,而忽略了周围组件的影响。购买此类装置的用户虽然可以放心芯片的散热性能符合规格,但对于相邻组件的散热情况却无从得知。
其他散热方案
电路板热分析可以识别出那些未采用液冷但存在过热风险的组件。在这种情况下,现有的散热技术无法达到完全液冷的效果。“在没有强制风冷的情况下,仍然有很多技术可以利用,”Tharp 指出。
有些技术涉及液体,但液体是独立存在的。例如,蒸汽室和热管。
均热板利用小体积内的对流,使液体接触芯片封装的顶部。液体蒸发并上升到该体积的顶部,在那里与外部冷板相互作用,冷板将蒸汽冷却并重新凝结成液体。对流使液体和蒸汽持续流动,从而有效地散热。
热管看起来几乎和液冷系统一样。它们也使用液体,但缺乏完整的液冷系统所需的庞大冷却基础设施。它就像一个迷你版的液冷装置。其原理很简单,就是将芯片(尤其是空间狭小、难以添加其他散热装置的芯片)产生的热量转移到其他地方,以便更有效地散热。这种转移是由产生的热量驱动的,所以它并不是永动机。
Synopsys公司SoC工程高级工程师Satya Karimajji表示:“内部的冷却剂在蒸发器侧吸收热量后会相变成蒸汽。蒸汽从蒸发器流向冷凝器。在冷凝器中,散热器或风扇会带走蒸汽的热量,然后蒸汽冷凝,冷凝后的液体通过毛细作用送回封装。”
这些技术最初是为不同类型的系统而发明的。“热管和均热板通常用于笔记本电脑或手机等小型设备,”卡里马吉说道。但它们的应用范围可能会进一步扩大。
有些情况下可能不需要如此复杂的装置。散热片通常通过气流散热,但即使没有气流,设计良好的散热片也能通过提供更大的散热表面积来改善冷却效果。
在电路板空间允许的情况下,一些工程师会在电路板上安装小型风扇以提供额外的气流。这些风扇可能会占用相当多的空间,而且它们的位置对于确保相关组件获得充足的气流至关重要。如果将空气排出电路板外部就足够了,那么这种方法或许可行。但如果需要进一步将空气从电路板外部排出,则需要重新安装之前在液冷散热过程中移除的空气流通系统。
旋转风扇通常体积较大,虽然小型版本或许可以安装在电路板上,但对于空间极其受限的系统,例如智能眼镜,则根本无法安装。此外,它们通常噪音也比较大。
另一种方法是将微机电系统 (MEMS) 单元放置在发热的芯片上,使其充当微型风扇。这种单元有两个端口,一个用于进气,另一个用于排气。安装在芯片封装顶部时,预留的支架区域为风扇和芯片之间的空气流通提供了空间;或者,也可以使用侧面通风的型号,无需支架即可直接安装在芯片上。
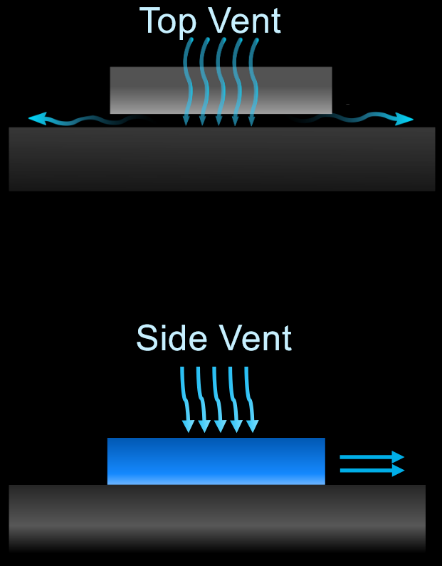
图 2:两种将 MEMS 风扇放置在芯片顶部的方式。在顶部安装方式中,支架在芯片下方留出空间,使空气能够横向流动,甚至向上从顶部通风口排出。采用侧面通风口时,则无需支架。来源:xMEMS
xMEMS的这款产品源自该公司原有的扬声器业务。MEMS扬声器通常利用压电效应,通过改变信号的电压来驱动振膜,进而带动空气运动。我们感知到的空气运动就是声音。“我们使用压电元件作为致动器,硅材料作为振膜,”xMEMS市场营销和业务发展副总裁Mike Housholder表示,“根据驱动MEMS的谐振频率以及对超声波的调制方式,我们可以产生音频,也可以产生气流。”
同样的原理可以制造出一种以恒定或可变速度运转的风扇,但它不像扬声器那样具有调制功能。配套的专用集成电路芯片驱动压电元件振动,振动带动空气通过端口流动。空气可以双向流动——从底部进入,从顶部排出,或者反之亦然。例如,可以使其沿一个方向流动用于冷却,而沿相反方向流动用于清洁。
“系统处理器通过I2C指令在ASIC芯片中设置气流方向,”Housholder说道。“气流方向可以随时改变,气流速率也可以实时动态调节。气流由电压控制。电压升高,气流增大;电压降低,气流减小。”
比普通风扇更安静
考虑到这项技术的音频渊源,值得注意的是,其频率在千赫兹范围内,通常远低于电路板上任何元件的频率。需要极高的泛音才能干扰任何电子设备。而且,风扇频率与芯片频率之间相差六个或更多数量级,如此巨大的频率差使得任何可察觉的泛音都难以产生影响。
风扇的另一个常见问题是噪音。人类的听觉范围在千赫兹以内,但这款风扇的运行频率超过40千赫兹,是人类通常能听到的最高频率的两倍。因此,它运行起来非常安静。
“在3厘米处没有机械噪音,”豪斯霍尔德说。“我们的噪音特征,也就是气流声,只有18分贝(dBA),人耳听不到。”(dBA是根据人耳的听觉响应特性加权的分贝值。作为对比,轻声细语的音量约为30分贝。)该公司还声称,他们的产品不受外部振动的干扰。
为了确保空气能够到达正确的位置,可能还需要采取一些额外的措施。“以固态硬盘(SSD,该公司支持的一种应用)为例,我们使用金属屏蔽罩——有点像射频电磁干扰屏蔽罩,”Housholder说道。“它也可以是塑料的——材质并不重要。我们引导气流流经屏蔽罩下方的所有芯片。根据风道或气流通道的设计,我们可以从外部或系统的其他位置吸入冷空气。”
xMEMS公司正在研究利用这项技术冷却HBM堆叠芯片,但它无法冷却堆叠芯片的顶部。一种可能的替代方案是冷却侧面。这有助于冷却堆叠芯片中中间的芯片,因为中间的芯片是最难冷却的。
MEMS冷却器可以安装在芯片上或电路板上。该公司甚至可以将其制成芯片级组件,并封装在先进的封装中。然而,要实现这一点,需要将金属盖更换为硅盖,并且先进的封装还需要配备进气口和出气口。
主动式散热器
该公司还在探索一种名为“主动式散热器”的技术,即将风扇安装在散热器顶部。大多数散热器必须在鳍片或针脚之间留出足够的空间,以保证正常的空气流通。这就引出了背压的概念,背压表示气流受到的阻力大小。对于传统风扇来说,背压很低,但对于微型风扇来说,由于它直接对着散热器顶部吹风,背压要高得多。这意味着散热器可以使用更密集的针脚阵列来增加表面积,从而提高散热效率。
“我们利用背压优势,使空气在狭小空间内流动,”豪斯霍尔德解释说。“这样可以精准地将冷却力集中到特定的热点区域,而风扇则更像是大范围的气流吹拂。”
尺寸为 9 × 7 毫米²,厚度为 1 毫米。价格在 5 到 10 美元之间。它们最初是为智能手机和 AR 眼镜设计的,这些产品或许能够接受这个价格,但对于一些价格不断上涨的消费品来说,销售可能会比较困难。它们首次涉足数据中心领域是在固态硬盘 (SSD) 中。
它仅适用于发热量适中的组件。“微冷却可以对功率在 15 到 18 瓦以下的系统产生影响,”Housholder 说。“这取决于具体的系统散热架构。”
有些未散热的芯片需要散热。如果改用液冷,或者即使未散热的系统发展到需要散热的地步,也需要进行全板分析,以确定哪些芯片发热、温度适中或散热良好。
数据中心内,发热芯片通常采用液冷散热。在数据中心之外,人们不太可能遇到液冷基础设施,因此,在现有技术条件下,微型风扇可以帮助冷却功耗不超过 20 瓦的发热芯片。如果功耗超过 20 瓦,且没有真正的液冷散热,那么如果气流不足,则可能需要采取措施来降低芯片的发热量。
以前无需额外散热的发热芯片,现在可能需要散热片、均热板、热管或局部风扇。低温芯片也会升温,但仍应在其预期的工作范围内运行。
随着越来越多的系统采用液冷散热,以及功耗水平的提高,对于那些需要辅助散热但无需完全液冷的芯片来说,可能会出现更多选择。无论何时可用散热方案如何,部署这些方案始终需要进行全面的电路板分析。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。




