DPA,半导体可靠性的终极验证
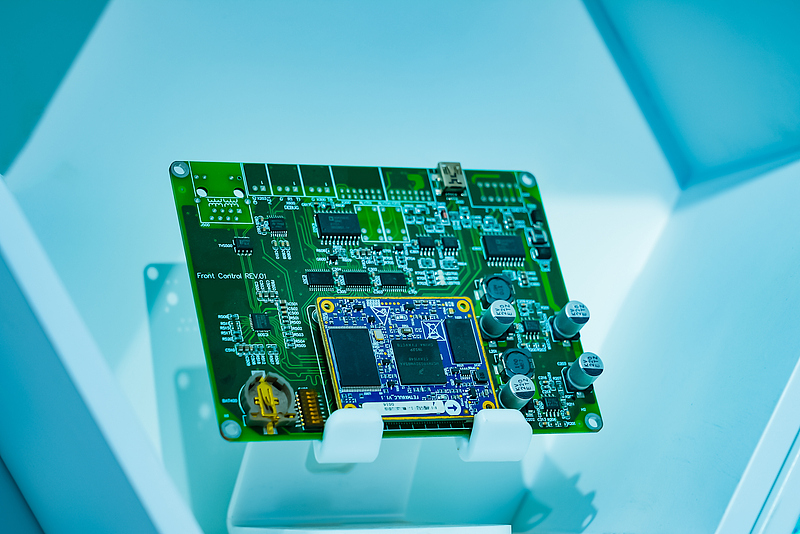
在半导体失效分析(FA)中,检测通常从无损分析开始,这类方法可在保留样品完整性的前提下帮助分析人员建立初步假设。但当无损手段无法消除结构上的不确定性、或无法验证器件内部构造时,就需要开展破坏性物理分析(DPA)。
无损方法虽能提供有价值信息,却未必能定位根本问题。内部界面往往无法触及,仅靠间接观测也难以区分相互矛盾的失效假设。
当这类分析瓶颈持续存在时,就必须通过破坏性拆解来获取确凿的结构证据。
一、标准体系:高可靠性半导体项目中的DPA 管理规范
在高可靠性半导体项目中,破坏性物理分析在一套明确的标准框架下执行,这套框架规定了元器件如何评估、以及分析结果如何影响生产决策。
该框架分为三个相关领域:
- 性能规范
- 测试方法标准
- DPA 管理标准
性能规范(如 MIL‑PRF‑19500、MIL‑PRF‑38535)定义了半导体器件的整体要求,包括筛选流程、认证要求、质量管理要求与合格判定准则。
测试方法标准(如 MIL‑STD‑750、MIL‑STD‑883)规定了具体检测与测量的执行方式,涵盖射线检测、键合拉力测试、芯片剪切测试、密封性测试、扫描电镜(SEM)制样等流程。
DPA 管理标准(以 MIL‑STD‑1580 为代表)则直接规定破坏性物理分析的实施规则,包括抽样方案、合格与拒收准则、禁用材料分析、文件记录要求,以及 DPA 结果如何决定生产批次的处置方式。
这些标准的形成与半导体产业早期发展密切相关。在早期几十年里,美国军方采购是高端、高成本半导体元器件的主要市场,往往在新技术实现商用经济性之前就率先采用。军方与 NASA 航天项目对可靠性的严苛要求,推动形成了如今仍在主导高可靠性电子领域的半导体质量与可靠性标准体系。
在这套框架下,DPA 严格按照既定抽样方案、检测方法与合格准则执行,标准明确了 DPA 如何开展、以及分析结果如何影响生产批次的最终判定。
二、破坏性拆解的合理性及其解决的不确定性
简单来说:当仅靠无损评估无法消除结构模糊性,或需要对内部结构进行正式验证时,破坏性拆解就具备合理性。
因此,DPA 仅针对生产批次中指定的样品开展,是高可靠性半导体项目中审慎、可控的一步,目的是回答关于器件结构、制造质量、材料完整性或失效机理的特定悬而未决问题。
1. 内部结构可视化验证
当内部构造、键合形态或材料界面存在疑问时,破坏性拆解可提供直接验证。
通过化学、激光或机械方式进行开盖(Decapsulation),可暴露芯片与互连结构,以便按照标准方法进行内部目视检查。暴露后,将通过光学显微镜与扫描电镜(SEM)对芯片表面、键合焊盘及可见标记进行记录。
SEM 对金属化层的检测,在评估非平面氧化层芯片的互连质量时尤为重要,能够识别出与批次相关、且无损方法无法检出的工艺类金属化缺陷。
当检测需要深入到表面以下时,通常借助聚焦离子束(FIB)进行逐层剥离(Delayering),以获得更深层的结构信息。通过自上而下、可控地逐层去除制造层,可对每一层工艺进行检查,评估金属化连续性、介质完整性及通孔成型与质量。这种方法常用于怀疑互连叠层内部存在缺陷、且表面检测或射线成像无法定位的场景。
剖面制备(Cross‑sectioning) 则可直接观察内部材料与结构界面。二极管、电容器、塑封微电路(PEM)等器件常通过剖面分析来识别裂纹、空洞、分层或结构异常,这些缺陷均无法通过无损方式确认。内部目视检查、SEM 分析与剖面观察得到的结果,会与基准设计文档及相关规范中的合格准则进行比对验证。任何与批准设计、材料或工艺要求不符的情况,都将按对应标准记录为缺陷。
2. 装配与互连完整性
除验证器件结构外,DPA 还用于评估装配界面的可靠性。
结构不确定性往往出现在这些界面上——机械与电气连接必须保证长期可靠性。在半导体封装中,金丝、铝丝或铜丝键合为硅芯片与外部引脚提供电气通路。
通过键合拉力测试评估这些键合的机械可靠性,测量键合强度分布,并验证是否满足强度要求。键合剪切测试则评估球形键合与芯片或封装键合面之间冶金结合的强度与完整性。这些方法可判断键合成型、金属间化合物生长或界面附着力是否满足既定合格标准。
同样,芯片剪切测试用于评估芯片与封装底座或基板之间粘接材料与工艺的可靠性。通过施加可控力将芯片从粘接面剥离,根据测得的力值与断裂特征,对照相关标准限值进行判定。
在上述场景中,DPA 将概率性推断转化为直接结构观测。不再仅依赖电信号或间接成像,而是通过可控暴露与物理界面测量来消除不确定性。
三、权衡与不可逆风险
DPA 能提供确凿的结构证据,但也伴随着可量化的代价。是否开展 DPA,需要在信息收益与样品损耗、时间成本、工艺风险之间权衡。
样品损耗与统计假设
DPA 本质是基于抽样的方法,其有效性依赖一个前提:被测样品能够代表整个生产批次。当工艺管控较弱时,需要更大样本量才能获得统计置信度,这会增加材料消耗与成本。
此外,由于 DPA 会彻底损坏被测样品,批次有效良率会直接因抽样数量而下降。
成本、周期与生产暴露风险
DPA 同样带来运营开销:剖面制备、金属化检测、键合测试及文件记录所需的人力、设备与专业分析能力都是不可忽视的投入。
在某些情况下,认证或产线末端测试周期很长。若经过长时间分析才发现缺陷,从生产到问题暴露的延迟可能导致同一缺陷工艺继续生产更多批次,这些后续批次可能需要隔离或重新评估,进一步放大成本与进度影响。
人为引入损伤与证据风险
破坏性拆解本身存在技术风险。
例如,化学开盖所用的酸液可能残留在封装材料或键合丝凹坑内,若未充分中和与清洗,残留物质会在开盖后继续腐蚀并降低键合可靠性。缓解措施包括溶剂清洗、中和处理、可控干燥,以及在开盖后尽快完成拉力或剪切测试。
四、DPA:为获取深度信息而进行的可控递进式分析
破坏性物理分析不是为了破坏而破坏,而是在无损方法达到极限、或标准要求直接验证时,开展的可控结构解析。
在高可靠性半导体项目中,DPA 将悬而未决的模糊性转化为可靠的物理证据。在规范抽样与严格文档记录下执行时,它能提供必要的结构确定性,支撑器件认证、批次判定与长期可靠性保障。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。





