明年全球CoWoS产能需求将暴涨113%
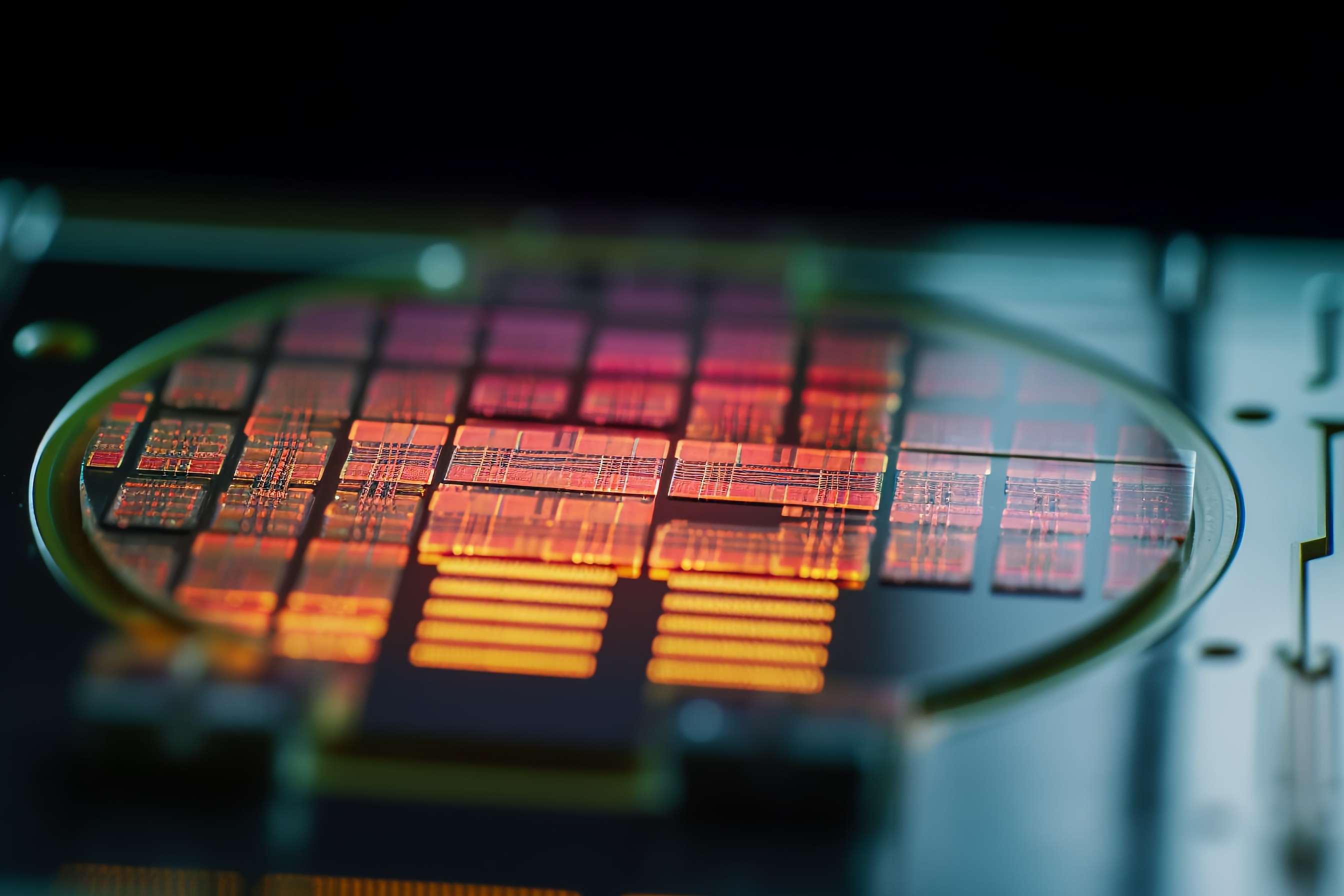
据 DIGITIMES Research 称,受云端 AI 加速器强劲需求的推动,全球对晶圆上芯片 (CoWoS) 和类似 CoWoS 的封装产能的需求可能在 2025 年每年增长 113%。
主要供应商台积电、日月光科技(包括矽品精密工业、SPIL)和安靠(Amkor)都在扩大产能。根据 DIGITIMES Research 最新发布的全球 CoWoS 封装技术与产能报告,到 2025 年第四季末,台积电的月产能预计将增加至 65,000 片 12 英寸晶圆以上,而安靠和日月光合计的产能将增加至 17,000 片晶圆。
DIGITIMES Research预估,受惠于Nvidia Blackwell系列GPU的量产,台积电将从2025年第四季开始从CoWoS-Short(CoWoS-S)工艺过渡至CoWoS-Long(CoWoS-L),届时CoWoS-L将成为台积电CoWoS技术的主导工艺。
DIGITIMES Research观察,为满足GB200系统需求,Nvidia大幅增加高端GPU出货量,大举下单台积电CoWoS产能;同时,为谷歌、亚马逊提供ASIC设计服务的博通、Marvell等公司也不断增加晶圆起订量。
尽管人们持续担心云服务提供商(CSP)在AI方面的资本投入与实际收入回报之间的差距,但DIGITIMES Research认为,CSP将在2025年继续处于AI投资阶段,从而推动全球对2.5D先进封装的需求。
由于对 CoWoS 和类似封装产能的需求强劲,台积电和日月光(包括矽品)正在提高相关产能以满足客户需求。预计到 2025 年底,台积电的 CoWoS 月封装产能将超过 65,000 片晶圆,而 Amkor 和日月光合计产能将增加到 17,000 片晶圆。报告数据显示,Nvidia 是台积电 CoWoS 封装工艺的最大客户。
值得注意的是,由于英伟达 Blackwell 系列芯片量产,台积电 CoWoS 制程将从 CoWoS-S 转向 CoWoS-L。英伟达对 CoWoS-L 制程的需求可能会从 2024 年的 3.2 万片大幅增加到 2025 年的 38 万片晶圆,同比增长 1018%。因此,DIGITIMES Research 估计,2025 年第四季度,CoWoS-L 将占台积电总 CoWoS 产能的 54.6%,CoWoS-S 为 38.5%,CoWoS-R为 6.9%。
中国制造商将受益于类似 CoWoS 的架构和台积电订单过剩
台积电 (TSMC) 仍然是全球唯一能够提供完整端到端晶圆上芯片 (CoWoS) 封装解决方案的供应商。对于中国制造商来说,问题来了:前端晶圆制造和先进封装公司扮演什么角色,它们服务于哪些市场?
三星电子计划推出自己的类似 CoWoS 的封装解决方案,品牌为 I-CUBE/H-CUBE。三星利用其供应高带宽内存 (HBM) 和 CoWoS 式封装的能力,旨在与台积电争夺订单。然而,生产能力要到 2024 年之后才能实现,而且该解决方案仍需要客户验证。
CoWoS 封装技术和 HBM 集成
以目前NVIDIA、AMD等公司的AI GPU芯片架构来看,CoWoS封装是HBM集成的关键,而生成式AI热潮带动AI-HPC计算需求激增,催生出“类CoWoS”结构,形成新的产业分工:Chip-on-Wafer(CoW)+ Wafer-on-Substrate(WoS)。
在这个模式中,台积电制造 GPU 晶圆和中介层,完成“晶圆上的芯片”堆叠和互连。然后,产品被转移到 OSAT 供应商,以完成“基板上”部分,将其封装到基板上。
据报道,中国制造商拥有一些 CoWoS 产能,主要通过 CoW+WoS 工艺集成。
CoW+WoS模式:行业适应与中国参与
能够使用台积电服务的中国 AI 芯片设计公司更看重台积电而非中芯国际。中芯国际在先进工艺节点和中介层生产方面落后于台积电,面临产能限制,必须支持其他中国制造商。在前端 CoW 工艺中,中芯国际只能“充分供应”。
中国 OSAT 供应商已为先进制程技术和产能做好了准备,除了与中芯国际在某些项目上合作外,他们还有更多机会从台积电的溢价订单中获利,类似于 Amkor 和日月光,满足中国以外的 AI-HPC 计算需求。
联电和格芯 (GF) 也可以提供硅中介层制造。联电最近表示,其打算专注于 HPC 中介层和用于 AI 应用的后端先进封装。虽然格芯没有明确瞄准 HPC 中介层机会,但它一直在扩大其在中国市场的影响力。该公司最近宣布了其中国业务领导层的变动,这一举措值得密切关注,因为它可能会影响该领域未来的潜在发展。
台积电的 CoWoS 主导地位和新兴竞争对手
尽管 CoWoS 并不需要极为先进的技术,但高良率对于封装配备 HBM 的 AI 芯片尤为重要。封装良率低会导致 HBM 等堆叠器件出现不可挽回的损失。
目前,只有台积电能够兼顾先进工艺节点和高良率。不过,三星也正在觊觎这一利润丰厚的市场,而英特尔的 Foveros 封装解决方案也值得关注,有望进入这一市场。
随着台积电产能收紧,安靠、日月光以及中国通富微电子和长电科技等公司正在争夺 CoWoS 溢价机会。然而,适合高良率先进计算芯片工艺的产能仍然有限,而这正是台积电在吸引订单方面保持主导地位的关键。
业界认为CoW+WoS是合理的分工,越来越多的“类似CoWoS”的供应链正在涌现。中国前端先进工艺逻辑芯片和硅中介层产能仍处于“充足”水平。至于后端WoS封装和测试,中国供应商可以处理国内和国外的溢价订单,但成熟的良率仍然在其竞争力中发挥着至关重要的作用。
本文转自媒体报道或网络平台,系作者个人立场或观点。我方转载仅为分享,不代表我方赞成或认同。若来源标注错误或侵犯了您的合法权益,请及时联系客服,我们作为中立的平台服务者将及时更正、删除或依法处理。




